Введение в микроэлектронику
| Примечание | Краткий курс лекций для заочного ускоренного обучения |
| Загрузить архив: | |
| Файл: ref-25242.zip (861kb [zip], Скачиваний: 265) скачать |
Воронежский государственный технический университет
М.И. Горлов
Введение в микроэлектронику
Краткий курс лекций для заочного ускоренного обучения
Воронеж 2018
Глава 1. Исторический обзор развития микроэлектроники.
1.1. Основные направления развития электроники.
Электроника – это наука, изучающая явления взаимодействия электронов и других заряженных частиц с электрическими, магнитными и электромагнитными полями, что является физической основой работы электронных приборов и устройств (вакуумных, газозарядных полупроводниковых и других), используемых для передачи, обработки и хранения информации.
Охватывая широкий круг научно-технических и производственных проблем, электроника опирается на достижения в различных областях знаний. При этом, с одной стороны, электроника ставит перед другими науками и производством новые задачи, стимулируя их дальнейшее развитие, и с другой – снабжает их качественно новыми техническими средствами и методами исследований.
Основными направлениями развития электроники являются: вакуумная, твердотельная и квантовая электроника.
Вакуумная электроника – это раздел электроники, включающий исследования
взаимодействия потоков свободных электронов с электрическими и магнитными
полями в вакууме, а также методы создания электронных приборов и устройств, в
которых это взаимодействие используется. К важнейшим направлениям исследования
в области вакуумной электроники относятся: электронная эмиссия (в частности,
термо- и фотоэлектронная эмиссия); формирование потока электронов и / или ионов
и управления этими потоками; формирование электромагнитных полей с помощью
устройств ввода и вывода энергии; физика и техника высокого вакуума и др.
Основные направления развития вакуумной электроники связаны с созданием электровакуумных приборов следующих видов: электронных ламп (диодов, триодов, тетродов и т.д.); электровакуумных приборов сверхвысокой частоты (например, магнетронов, клистронов, ламп бегущей и обратной волны); электроннолучевых и фотоэлектронных приборов (например, кинескопов, видиконов, электронно-оптических преобразователей, фотоэлектронных умножителей); газоразрядных приборов (например, тиратронов, газозарядных индикаторов).
Твердотельная электроника решает задачи, связанные с изучением свойств
твердотельных материалов (полупроводниковых, диэлектрических, магнитных и др.),
влиянием на эти свойства примесей и особенностей структуры материала; изучением
свойств поверхностей и границраздела
между слоями различных материалов; созданием в кристалле различными методами
областей с различными типами проводимости; созданием
гетеропереходов и монокристаллических структур; созданием функциональных устройств микронных и субмикронных размеров, а также способов измерения их параметров.
Основными направлениями твердотельной электроники являются: полупроводниковая электроника, связанная с разработкой различных видов полупроводниковых приборов, и микроэлектроника, связанная с разработкой интегральных схем.
Квантовая электроника охватывает широкий круг вопросов, связанных с разработкой методов и средств усиления и генерации электромагнитных колебаний на основе эффекта вынужденного излучения атомов и молекул. Основные направления квантовой электроники: создание оптических квантовых генераторов (лазеров), квантовых усилителей, молекулярных генераторов и др. Особенности приборов квантовой электроники следующие: высокая стабильность частоты колебаний, низкий уровень собственных шумов, большая мощность в импульсе излучения - которыепозволяют использовать их для создания высокоточных дальномеров, квантовых стандартов частоты, квантовых гироскопов, систем оптической многоканальной связи, дальней космической связи, медицинской аппаратуры, лазерной звукозаписи и воспроизведения и др. Созданы даже миниатюрные лазерные указки для минимального сопровождения.
1.2. История развития микроэлектроники.
Микроэлектроника является продолжением развития полупроводниковой электроники, начало которой было положено 7 мая 1895 года, когда полупроводниковые свойства твердого тела были использованы А.С.Поповым для регистрации электромагнитных волн.
Дальнейшее развитие полупроводниковой электроники связанно с разработкой в 1948 году точечного транзистора (американские ученые Шокли, Бардин, Браттейн), в 1950 году – плоскостного биполярного транзистора, а в 1952 году полевого (униполярного) транзистора. Наряду с транзисторами были разработаны и стали широко использоваться другие различные виды полупроводниковых приборов: диоды различных классов и типов, варисторы, варикапы, тиристоры, оптоэлектронные приборы (светоизлучающие диоды, фотодиоды, фототранзисторы, оптроны, светодиодные и фотодиодные матрицы).
Создание транзистора явилось мощным стимулом для развития исследований в области физики полупроводников и технологий полупроводниковых приборов. Для практической реализации развивающейся полупроводниковой электроники потребовались сверхчистые полупроводниковые и другие материалы и специальное технологическое и измерительное оборудование. Именно на этой базе стала развиваться микроэлектроника.
Следует отметить, что основные принципы микроэлектроники – групповой метод и планарная технология – были освоены при изготовлении транзисторов в конце 50 годов.
Первые разработки интегральных схем (ИС) относятся к 1958 – 1960г.г. В 1961 – 1963г.г. ряд американских фирм начали выпускать простейшие ИС. В то же время были разработаны пленочные ИС. Однако некоторые неудачи с разработками стабильных по электрическим характеристикам пленочных активных элементов привели к преимущественной разработке гибридных ИС. Отечественные ИС появились в 1962 – 1963г.г. Первые отечественные ИС были разработаны в ЦКБ Воронежского завода полупроводниковых приборов (схемы диодно-транзисторной логики по технологии с окисной изоляцией карманов). По технологии изготовления эти схемы уступали 2 года западным разработкам.
В историческом плане можно отметить 5 этапов развития микроэлектроники.
Первый этап, относящийся к первой половине 60-х годов, характеризуется степенью интеграции ИС до 100 элементов / кристалл и минимальным размером элементов порядка 10 мкм.
Второй этап, относящийся ко второй половине 60-х годов и первой половине 70-х годов, характеризуется степенью интеграции ИС от 100 до 1000 элементов/кристалл и минимальным размером элементов до 2 мкм.
Третий этап, начавшийся во второй половине 70-х годов, характеризуется степенью интеграции более 1000 элементов/кристалл и минимальным размером элементов до 1 мкм.
Четвертый этап, характеризуется разработкой сверхбольших ИС со степенью интеграции более 10000 элементов/кристалл и размерами элементов 0,1 – 0,2 мкм.
Пятый, современный, этап характеризуется широким использованием микропроцессоров и микро-ЭВМ, разработанных на базе больших и сверхбольших ИС.
Контрольные вопросы:
1.Дайте определение электроники как науки.
2. Назовите основные направления развития электроники.
3. Назовите основные направления твердотельной электроники.
4. Охарактеризуйте пять этапов развития микроэлектроники.
Глава 2. Общие сведения о полупроводниках
Развитие твердотельной электроники тесно связано с успехами физики и химии полупроводниковых материалов. По удельному сопротивлению ρ полупроводники занимают промежуточное место между металлами и диэлектриками. Для полупроводников ρ составляет 10-5-108 Ом·м, для диэлектриков 1016-1022 Ом·м, для металлов 10-8-10-6 Ом·м. Температурный коэффициент сопротивления у полупроводников отрицателен, т.е. с увеличением температуры их сопротивление уменьшается.
В отличие от металлов полупроводники сильно изменяют свои свойства от присутствия даже очень небольших концентраций примеси. У полупроводников заметное изменение ρ наблюдается также под действием света, ионизирующих излучений и других энергетических воздействий.
Так, например, при концентрации примесных атомов в полупроводнике около 10-4 атомных процентов его удельная проводимость изменяется на несколько порядков.
2.1. Полупроводники и их электрофизические свойства
Полупроводники — наиболее распространенная в природе группа веществ. К ним относятся химические элементы: бор (В), углерод (С), кремний (Si), фосфор (Р), сера (S), германий (Ge), мышьяк (As), селен (Se), олово (Sn), сурьма (Sb), теллур (Те), йод (I); химические соединения типа: AIBVII, AIIIBV, AIVBIV, AIBVI, AIVBVI, (GaAs, GeSi, CuO, PbS и др.); большинство природных химических соединений — минералов, число которых составляет около 2 тыс., многие органические вещества.
В электронике находит применение лишь ограниченное число полупроводниковых веществ. Исходные материалы, из которых изготавливают полупроводниковые приборы, должны обладать определенными физико-химическими и механическими свойствами.
Они должны иметь вполне определенное ρ в диапазоне рабочих температур ∆T. Такое удельное сопротивление можно получить при достаточно большом количестве свободных носителей заряда и их беспрепятственном движении в объеме полупроводника. Следовательно, необходимо твердое тело, в котором концентрация свободных носителей заряда n, их диффузионная длина L и время жизни τ были бы достаточно большими. Этим требованиям удовлетворяют в первую очередь монокристаллы, в которых в отличие от аморфных тел и поликристаллов обеспечивается высокая периодичность решетки. Однако не все монокристаллы обладают полупроводниковыми свойствами. А среди полупроводниковых кристаллов лишь немногие по своим параметрам и свойствам пригодны для изготовления полупроводниковых приборов.
На приведенном фрагменте таблицы Периодической системы элементов Д. И. Менделеева (рис. 2.1) жирной линией обведена область, в которой расположены элементы, обладающие полупроводниковыми свойствами. Слева и снизу от этой области расположены металлы, справа и сверху — диэлектрики.
Электропроводность твердого тела зависит от структуры внешних электронных оболочек его атомов, определяющих месторасположение элементов в таблице. Число справа внизу от химического символа обозначает ширину запрещенной зоны элемента в электрон-вольтах, число в правом верхнем углу — порядковый номер элемента в таблице.
Из рис. 2.1 видно, что полупроводниковыми свойствами обладают лишь 12 химических элементов. Среди них наиболее подходящими для производства полупроводниковых приборов оказались германий (Ge) и кремний (Si).
Германий встречается, главным образом, в сернистых минералах, некоторых силикатах и карбонатах, а также в каменных углях и богатых углем породах. Содержание Ge в земной коре всего 7·10-4%, он широко рассеян в горных породах. Для полупроводниковых приборов необходим Ge, почти не содержащий примесей других элементов. На 108 его атомов лишь один может быть чужеродным, но и то не любым, а принадлежащим к группе определенных «легирующих» элементов (чаще всего Sb, As, Ga, In, как показано на рис. 2.1 стрелками). Поэтому производство Geпредставляет известную сложность.

Рис. 2.1.
Кремний — наиболее распространенный (после кислорода) элемент, но в чистом виде он не встречается. Давно известным соединением Si является его двуокись SiO2. Твердая земная кора содержит 'по массе 27,6% кремния и состоит более чем на 97% из природных силикатов, т. е. солей кремниевых кислот, а также двуокиси кремния SiO2 преимущественно в виде кварца. Для производства полупроводниковых приборов необходим также очень чистый Si. Получение чистых кристаллов кремния еще более сложно, чем кристаллов германия. Кремний имеет высокую температуру плавления (около 1500°С) и в расплавленном состоянии очень высокую химическую активность. Это резко повышает технологические трудности получения чистых кристаллов и легирования их нужными примесями (в качестве последних чаще всего используются В, Аl и Р, как показано на рис. 2.1). Поэтому чистый кремний, как и германий, довольно дорогой элемент.
Для изготовления полупроводниковых приборов применяют и Ge и Si, они не
являются конкурирующими элементами, так как сообщают приборам разные свойства.
Например, транзисторы из германия работают до
+(100-120)°С, а из кремния до +(150-200) °С. Однако германиевые транзисторы
работают при более низких температурах и обладают лучшими частотными характеристиками,
чем кремниевые, так как подвижность свободных носителей заряда в Ge выше.
На 2.1 указаны еще несколько элементов, обладающих полупроводниковыми свойствами. Однако большинство из них непригодно для изготовления полупроводниковых приборов: либо они проявляют полупроводниковые свойства при температуре меньше 20°С (S и I) или 13°С (Sn), либо только в виде пленок (Sb и As), они сублимируют (I и As), хрупки (Те), легко плавятся (Sn), недостаточно изучены (В) и пр.
В электронике поэтому находит применение лишь ограниченное количество химических элементов, обладающих полупроводниковыми свойствами. На первом месте стоят Ge и Si, используемые в качестве основы при изготовлении полупроводниковых приборов. Бор, фосфор, мышьяк, сурьма, индий, галлий, алюминий используют в качестве примесей. В последние годы начинают применять некоторые соединения, например, арсенид галлия (GaAs), антимонид индия (InSb) и др. Интересны также сплавы и соединения элементов IVгруппы периодической системы — карбид кремния, сплав кремний — германий и др. Однако они еще недостаточно изучены.
Основными параметрами Ge и Si, определяющими свойства изготовленных из них приборов, являются: ρ — удельное сопротивление; ∆ε— ширина запрещенной зоны; n- или p-концентрации свободных носителей заряда (электронов и дырок); δ — плотность дислокаций; L — диффузионная длина; τ — время жизни носителей заряда. Чтобы оценить эти параметры, необходимо рассмотреть основы физики полупроводниковых материалов.
2.2. Структура полупроводниковых кристаллов
Кристаллическое вещество представляет собой сплошную упорядоченную структуру (монокристалл) либо состоит из большого числа мелких монокристаллов, различно ориентированных в пространстве (поликристалл).
Кристаллические вещества анизотропны, т.е. их свойства зависят от кристаллографического направления.
Для описания закономерности строения кристаллов необходимо задание направления (прямой). Для задания направления в кристалле достаточно задать координаты любого атома тройкой целых чисел, заключенных в скобки (x,y,z). Если плоскость параллельна какой-либо из координатных осей, то индекс, соответствующей этой оси равен нулю. Основные кристаллографические плоскости кубической решетки показаны на рисунке 2.2.

Рис.2.2. - Основные кристаллографические плоскости кубической решетки
Кремний и германий представляют собой кристаллы с регулярной структурой. Кристаллическая решетка кремния и германия называется тетраэдрической или решеткой типа алмаза Основу решетки составляет тетраэдр — пространственная фигура, имеющая четыре треугольные грани. В вершинах тетраэдра и в его центре расположены атомы. Центральный атом находится на одинаковом расстоянии от четырех других, находящихся в вершинах. А каждый атом, расположенный в вершине, в свою очередь, является центральным для других четырех ближайших атомов.
При рассмотрении физических процессов в полупроводниковых материалах удобнее пользоваться плоским эквивалентом тетраэдрической решетки (рис. 2.3). Все атомы (большие шарики) находятся в парноэлектронной, ковалентной или просто валентной связи. Парноэлектронные связи (линии на рисунке) образуются валентными электронами (на рисунке — маленькие шарики) при сближении атомов. Так располагаются атомы чистых четырехвалентных элементов, в том числе Ge и Si, при очень низкой температуре.

Рис.2.3.
При выращивании монокристаллов из расплава очень трудно получить материалы со строго регулярной структурой. Обычно в процессе производства получаются неоднородности разных типов, нарушается периодичность кристаллической решетки, появляются дефекты.
Существуют разнообразные дефекты кристаллических решеток.
Нульмерные или точечные дефекты, к которым относятся например, межузельный атом или вакансия (рис. 2.4)
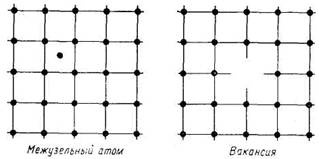
Рис. 2.4.
Одномерные или линейные дефекты, например, цепочки межузельных атомов, цепочки вакансий, дислокации.
Двухмерные или поверхностные дефекты, например, границы кристалла, зерен (кристаллитов), т. е. места, где нарушается периодичность решетки.
Трехмерные или объемные дефекты, например, инородные включения, размеры которых существенно больше характерного размера решетки, ее параметра а0. Для Ge постоянная решетки а0 равна 565 Å, для Si —543 Å.
К важнейшим дефектам кристаллических решеток относятся дислокации —специфические линейные дефекты, связанные с нарушением правильного чередования плоскостей, в которых располагаются группы атомов. Различают несколько видов дислокаций.
Дислокации могут служить центрами генерации и рекомбинации свободных электронов, они влияют на время жизни носителей заряда.
Плотность дислокаций δ определяется как отношение общей длины линий дислокаций к объему образца. Для изготовления полупроводниковых приборов применяют Ge и Si с плотностью дислокаций δ, не превышающей 104 на 1см2, причем для разных типов приборов существует свое предельное значение δ. Например, для сплавных транзисторов требуются Ge и Si с плотностью дислокаций до 103-5·104 см-2, для эпитаксиальных — до 102 см-2 и т. д.
Плотность дислокаций исходного полупроводникового материала во многом определяет электрические параметры приборов, а также разброс этих параметров от экземпляра к экземпляру. От плотности дислокаций в материале зависит и процент годных приборов в серийном производстве.
2.3. Свободные носители зарядов в полупроводниках
Изображенная на рис. 2.3 структура соответствует «гипотетическому» случаю для очень чистого полупроводникового монокристалла при очень низкой температуре. С повышением температуры происходит разрыв электронных связей (рис. 2.5), и часть электронов становится свободной, т. е. электронами проводимости. Такой же процесс происходит в полупроводниковых и под действием света. Разрыв электронных связей сопровождается не только появлением свободных электронов, но и образованием «дырок» — вакансий, т. е. пустых мест в атомах, которые покинул электрон.
«Дырка» — понятие, введенное в квантовой теории твердого тела. Дырка ведет себя подобно частице с элементарным положительным зарядом, равным заряду электрона, и массой, близкой к массе электрона.

Рис. 2.5.
Дырка, появившись одновременно со свободным электроном, перемещается в течение некоторого времени, называемого временем жизни, в кристалле замещением вакансий соседними электронами связи, а затем рекомбинирует с одним из свободных электронов (электроном проводимости).
В абсолютно чистом, так называемом «собственном» полупроводнике, электроны и дырки под действием тепла и света всегда образуются парами, т.е. в равном количестве. Число их в стационарном режиме определяется равновесием между процессами генерации и рекомбинации свободных носителей заряда (электронов и дырок). Генерация носителей — образование пар, рекомбинация— их исчезновение. Процессы генерации и рекомбинации идут непрерывно, их скорости равны. Электропроводность полупроводника, обусловленная парными носителями теплового происхождения, называется собственной.
Полупроводник, у которого n=p, называется собственным полупроводником или полупроводником с собственной проводимостью Концентрации электронов ni и дырок pi в собственном полупроводнике одинаковы (ni=pi) и зависят только от температуры, заметно возрастая с ее повышением (Индекс i здесь и далее относится к «собственным» полупроводникам, i — от английского слова intrinsic — настоящий).
Собственных полупроводников (идеальных кристаллов бесконечной протяженности) в природе не существует. Реальные кристаллы имеют конечные размеры, дефекты и примеси. И если в справочниках иногда приводят параметры «собственного» полупроводникового материала, то это означает лишь, что имеется в виду полупроводник, у которого концентрации примесей и дефектов ниже определенной величины.
Главную роль в полупроводниковой электронике играют примесные полупроводники, в которых концентрации электронов и дырок значительно различаются.
Любые примеси в полупроводниках приводят к существенному изменению их свойств. В частности, изменяется электропроводность полупроводника. В этом случае она называется примесной электропроводностью. Можно контролировать количество и тип вводимой примеси и, следовательно, электропроводность полупроводникового материала.
Различают примеси донорные («отдающие» электроны) и акцепторные («принимающие» электроны, образующие дырки в атомах полупроводника).
В качестве донорных примесей используются элементы V группы Периодической системы элементов Д. И. Менделеева: фосфор, мышьяк, сурьма и др. В качестве акцепторных — элементы III группы: бор, алюминий, галлий, индий и др. На рис. 2.1 стрелками показаны примеси для Ge и Si, наиболее широко используемые в промышленности.
Если ввести в кремний атом пятивалентного фосфора, то четыре из его пяти валентных электронов образуют с четырьмя электронами соседних атомов кремния парноэлектронные или ковалентные связи. Пятый электрон оказывается слабо связан с ядром и при самых незначительных тепловых колебаниях решетки становится свободным, т. е. электроном проводимости. Атом примеси при этом превращается в положительный ион с единичным зарядом. Атом, отдающий электрон, называется донором, а примесь —донорной. Образовавшиеся свободные электроны добавляются к «собственным» свободным электронам термогенерации и увеличивают проводимость кристалла. Концентрация «примесных» электронов, поскольку они слабее связаны с ядром, будет значительно превышать концентрацию «собственных» электронов, а следовательно, и дырок. Полупроводники с донорной примесью называются полупроводниками с электронной проводимостью или полупроводниками типа n (n — от negative — отрицательный). В полупроводнике типа n ток электронов значительно превышает ток дырок.
В примесном полупроводнике один тип подвижных носителей заряда преобладает над другим, поэтому принято те носители, которые составляют большинство, называть основными, а те, которых меньшинство, — неосновными.
Таким образом, основными носителями заряда в электронном полупроводнике являются электроны, а неосновными — дырки, и, следовательно, в полупроводнике n-типа концентрация электронов значительно больше концентрации дырок nn> pn, но nnpn= ni2
Если в кремний ввести атом трехвалентного бора, то для валентной связи бора с четырьмя ближайшими атомами кремния необходимо четыре валентных электрона, а на его верхней валентной оболочке их лишь три. Недостающий электрон отбирается из основной решетки и тогда атом бора превращается в отрицательный ион. А на месте покинувшего атом кремния электрона образуется дырка. Атом, принимающий электрон, называется акцептором, а примесь — акцепторной. Полупроводники с акцепторной примесью называются полупроводниками с дырочной проводимостью или полупроводниками типа р (р — от positive — положительный). В полупроводнике типа р дырочная электропроводность значительно превосходит электронную.
Основными носителями заряда в дырочном полупроводнике являются дырки, а
неосновными — электроны, и, следовательно, в полупроводнике
p-типа концентрация дырок значительно больше
концентрации электронов, pp>np, но всегда nppp=
ni2.
Если в полупроводник n-типа ввести акцепторную примесь концентрации равной концентрации носителей n-типа, то такой полупроводник называется компенсированным.
Полупроводник, у которого число носителей не менее 1020 на 1см3, называется вырожденным полупроводником.
2.4. Элементы зонной теории твердого тела.
Анализ процессов, происходящих в полупроводниковых материалах и полупроводниковых приборах, основывается на зонной теории твердого, тела, учитывающей различные квантовомеханические эффекты.
Твердое тело, в том числе рассматриваемые полупроводниковые монокристаллы, представляет собой систему, состоящую из большого числа атомов, плотность которых составляет примерно 1022 на 1 см3. Каждый атом характеризуется дискретным спектром энергий ε1, ε2,ε3, … ,εn разрешенных для электронов.
По представлениям квантовой механики состояние электрона в атоме характеризуется квантовыми числами. Электроны в атоме могут занимать только вполне определенные, разрешенные энергетические уровни. В нормальном (невозбужденном) состоянии атома электроны должны располагаться на самых низких энергетических уровнях.
Однако в соответствии с принципом Паули в одном и том же атоме (или в какой-либо квантовой системе) не может быть двух электронов, обладающих одинаковой совокупностью квантовых чисел. Поэтому электроны в соответствии с их состояниями распределяются по определенным оболочкам вокруг ядра. Атом кремния имеет 14 электронов, расположенных на трех оболочках по 2, 8 и 4 электрона. Атом германия имеет 32 электрона, расположенных на четырех оболочках по 2, 8, 18 и 4 электрона. Валентные электроны на последней (верхней) оболочке, имеющие набольшую энергию, определяют электропроводность кремния и германия.
Практическое следствие из принципа Паули при рассмотрении германия и кремния заключается в том, что при объединении двух атомов происходит расщепление каждого уровня на два, а при объединении N атомов в кристалл происходит расщепление каждого энергетического уровня на N уровней.
В рассматриваемом случае находящиеся на очень близком энергетическом расстоянии отдельные уровни, образовавшиеся при объединении множества атомов Ge или Si в кристалл, становятся практически неразличимы. Совокупность близко расположенных энергетических N уровней называется энергетической зоной.
Разрешенные энергетические зоны отделены друг от друга запрещенными энергетическими участками, которые называются запрещенными зонами. Ширина запрещенных зон зависит от расстояния между атомами, т.е. определяется строением кристаллической решетки, а также строением и состоянием атомов, образующих монокристалл.
Для рассмотрения физических процессов в полупроводниках и полупроводниковых приборах интерес представляют только три верхние энергетические зоны: валентная, запрещенная и свободная, или зона проводимости, так как именно эти зоны обусловливают электропроводность полупроводника.
Электропроводность возможна лишь тогда, когда возможен переход электрона на другой энергетический уровень. Это означает, что в проводимости могут участвовать электроны только тех зон, где есть свободные уровни, а при температуре абсолютного нуля они имеются лишь в самой верхней разрешенной зоне, которую называют поэтому зоной проводимости. Нижний энергетический уровень зоны проводимости обозначается εc. В зоне проводимости находятся электроны, осуществляющие электропроводность кристалла.
Зона проводимости отделена от валентной запрещенной зоной, ширина которой обозначается ∆ε.
Валентная зона — зона, в которой все энергетические уровни заняты при температуре абсолютного нуля, поэтому электроны этой зоны не могут участвовать в проводимости. Однако с повышением температуры электроны переходят из валентной в зону проводимости, в валентной зоне образуются свободные уровни и появляется возможность перехода на них электронов.

Рис. 2.6.
Верхний энергетический уровень валентной зоны обозначается εv.
Электропроводность твердых тел зависит от взаимного расположения зоны проводимости и валентной зоны. Именно по характеру энергетических диаграмм твердые тела более четко разделяются на проводники (металлы), полупроводники и диэлектрики (изоляторы) (рис. 2.6).
В металлах зона проводимости и валентная зона перекрываются, и электроны валентной зоны могут легко переходить в зону проводимости независимо от температуры тела. В зоне проводимости электроны принадлежат всему твердому телу и свободно внутри него перемещаются. Проводящее состояние является обычным. В отличие от металлов при нулевой температуре у изоляторов и полупроводников зона проводимости пуста и электропроводность отсутствует.
Ширина запрещенной зоны ∆ε — один из важнейших параметров полупроводникового материала, определяющий его электрические и химических свойства. На рис. 2.1 числами справа внизу указаны значения ширины запрещенной зоны ∆ε в электронвольтах. Из рисунка видно, что чем больше число оболочек в атоме, тем меньше ширина запрещенной зоны и тем слабее связаны валентные электроны с ядром.
В отличие от металлов электропроводность полупроводника обусловлена электронами и дырками, т.е., кроме электронной, в полупроводнике существует и другой вид проводимости — дырочная. Переход электронов из валентной зоны в зону проводимости приводит к образованию дырок — вакантных уровней в валентной зоне. При температуре, отличной от нуля, в зоне проводимости полупроводника всегда имеется n электронов, а в валентной зоне — р дырок.
Переход электронов из валентной зоны в зону проводимости и образование дырки на освободившемся энергетическом уровне — процесс генерации носителей. Но наряду с генерацией происходит и рекомбинация носителей — переход электронов из зоны проводимости обратно в валентную зону на свободный уровень. При динамическом равновесии оба процесса идут непрерывно, их скорости равны.
Если в кристалле имеются дефекты, то создаваемое ими электрическое поле может захватить электрон, подобно тому как электрон захватывается свободными ионами. Локализованный вблизи дефекта электрон имеет энергию, соответствующую энергии запрещенной зоны.
При исследовании механизма электропроводности в полупроводниках обычно
считается, что такие уровни возникают в результате присутствия примесных
атомов. Поэтому сами уровни называются примесными. Если такой уровень
расположен вблизи зоны проводимости, то даже при небольшом повышении
температуры электроны будут переходить в эту зону, в результате чего они
получат возможность свободно перемещаться по кристаллу. Полупроводник, у
которого подвижные электроны возникают вследствие их перехода с примесных
уровней в зону проводимости, называют полупроводником с электропроводностью n-типа или
электронным
полупроводником. Уровни, поставляющие электрон в зону проводимости, называют донорными.
Если примесные уровни расположены вблизи потолка валентной зоны, то при
повышении температуры электроны валентной зоны могут захватываться ими, это
приводит к образованию подвижных дырок в валентной зоне. Полупроводник с таким
механизмом возникновения подвижных носителей заряда называют полупроводником с электропроводностью
p-типа и
дырочным полупроводником. Уровни, захватывающие электроны или генерирующие
дырки в валентной зоне, называют акцепторными. Зонные диаграммы
собственного (а), примесного
n-типа (б) и примесного p-типа (в) полупроводников показаны на рис.2.7.
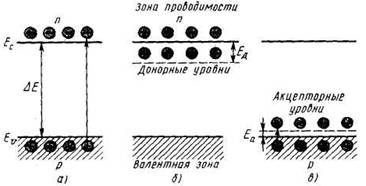
Рис. 2.7. - Зонные диаграммы полупроводников
Контрольные вопросы:
1. Как разделяются по удельному сопротивлению материалы?
2. Сколько элементов периодической системы относится к полупроводникам?
3. Охарактеризуйте элемент кремний.
4. Дайте определение собственного полупроводника.
5. Что называется примесным полупроводником?
6. Дайте определение компенсированного и вырожденного полупроводника.
7. Назовите три верхние энергетические зоны.
8. Нарисуйте зонную диаграмму полупроводника.
Глава 3. Методы получения монокристаллов кремния
Методов получения монокристаллов кремния в настоящее время очень много. Остановимся на двух наиболее распространенныхи длительно применяемых способах: метод Чохральского и метод зонной плавки.
3.1. Метод Чохральского
В расплавленное нагревателем 1 вещество 3 (в нашем случае поликристаллический кремний), которое находится в тигле 2 и имеет температуру, близкую к температуре плавления (для кремния температура плавления 1685о±2о), опускают монокристаллическую затравку 4 того же состава, что и расплав.

Рис.3.1
Далее приводят в действие подъемный механизм затравки, при этом затравка смачивается расплавом и увлекает его вверх, вследствие чего расплав на затравке нарастает в виде кристаллической фазы. Метод обеспечивает получение полупроводниковых материалов в форме совершенных кристаллов с определенной кристаллической ориентацией и с минимальным числом дефектов. Нижняя часть полученного слитка отрезается, т.к. в нем остается наибольшее число различных примесей, загрязнений. Наименьшее число дислокаций в кремнии получается при выращивании монокристаллов в направлении (111).
3.2. Метод зонной плавки
В некоторых случаях в технологии полупроводниковых материалов выращивают монокристаллы методом зонной плавки. Достоинством метода является совмещение процесса глубокой очистки полупроводника с последующим выращиванием его монокристалла.
В связи с различной растворимостью примесей в твердой и жидкой фазах зонная плавка является одним из наиболее эффективных и производительных методов глубокой очистки монокристаллов. При его реализации перед началом кристаллизации расплавляется не вся твердая фаза кристалла 1, а только узкая расплавленная зона 2, которую перемещают вдоль кристалла. Различают горизонтальную и вертикальную зонные плавки.
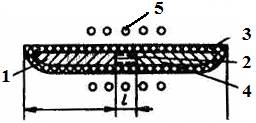
Рис.3.2.
3 – исходная загрузка, 4 – контейнер (тигель, ампула,
лодочка),
5 – нагреватель.
Большинство примесей обладает хорошей растворимостью в жидкой фазе по сравнению с твердой фазой, поэтому по мере продвижения зона плавления все больше насыщается примесями, которые скапливаются на конце слитка. Обычно процесс зонной плавки повторяют несколько раз, по окончании очистки загрязненный конец слитка отрезают.
Контрольные вопросы:
1. Расскажите о методе Чохральского.
2. В чем достоинства метода зонной плавки?
Глава 4. Электронно-дырочный переход.
Работа большинства полупроводниковых изделий основана на использовании электрического перехода. Электрический переход в полупроводнике – это граничный слой между двумя областями, физические характеристики которых существенно различаются.
Переходы между двумя областями полупроводника с разным типом электропроводности называют электронно-дырочным или p-n-переходом. Различают симметричные и несимметричные p-n-переходы. В симметричных переходах концентрация электронов в полупроводнике n-типа nn и концентрация дырок в полупроводнике p-типа pp равны, т.е. nn=pn. Другими словами, концентрация основных носителей зарядов по обе стороны симметричного p-n-перехода равны. На практике используются, как правило, несимметричные переходы, в которых концентрация, например, электронов в полупроводнике n-типа больше концентрации дырок в полупроводнике p-типа, т.е. nn>pp, при этом различие в концентрациях может составлять 100-1000 раз. Низкоомная область, сильно легированная примесями (например n-область в случае nn>pp), называется эмиттером; высокоомная, слаболегированная (p-область в случае перехода nn>pp), - базой. Для случая когда концентрации электронов в полупроводнике р-типа больше концентрации электронов в полупроводнике n-типа, т.е. pp>nn, эмиттером будет p-область, а базой n-область.
В зависимости от характера примесей, обеспечивающих требуемый тип электропроводности в областях, различают два типа переходов: резкий (ступенчатый) и плавный (линейный). В резком переходе концентрация примесей на границе раздела областей изменится на расстоянии, соизмеримом с диффузионной длиной, в плавном – на расстоянии, значительно большем диффузионной длины. Лучшим выпрямительными (вентильными) свойствами обладают резкие p-n-переходы. Резкий p-n-переход образуется при сплавлении, плавный – получается методом диффузии или методом выращивания из расплава.
В зависимости от площади p-n-переходы разделяются на точечные и плоскостные. Плоскостные переходы в зависимости от метода их изготовления бывают сплавными, диффузионными, эпитаксиальными и т.п.
Переходы между двумя областями с одним типом электропроводности (n- или p-типом), отличающиеся концентрацией примесей и соответственно значением удельной проводимости, называют изотипными переходами: электронно-электронными (n+-n-переход) или дырочно-дырочными (p+-p-переход). Термином n+ - обозначают область с концентрацией электронов, большей nконцентрации, а p+ - область с концентрацией дырок, большей p; следовательно, слои n+ и p+ имеют меньшее удельное сопротивление, поэтому большую удельную проводимость.
Переходы между двумя полупроводниковыми материалами, имеющими различную ширину зоны, называют гетеропереходами, например карбид кремния. Если одна из областей, образующих переход, является металлом, то такие переходы называют переходом металл-полупроводник, которые могут обладать вентильными свойствами или омическими.
4.1. Образование p-n-перехода.
Электронно-дырочный переход (p-n-переход) находится на границе между двумя областями полупроводника, одна из которых имеет электронную (n), а другая – дырочную (p) электрические проводимости, т.е. соответственно n- или p-области. Однако его нельзя создать простым соприкосновением полупроводниковых пластин n- или p-типов, так как при этом неизбежен промежуточный слой воздуха, оксидов или поверхностных загрязнений. Переход создается в кристалле полупроводника с помощью технологических процессов (например, сплавления, диффузии), в результате которых граница раздела между областями p- и n-типов находится внутри полупроводникового монокристалла.
На рис.4.1 условно показан кристалл, одна часть объема которого имеет дырочную электропроводность, а другая – электронную.
До установления термодинамического равновесия между p- и n-областями и в отсутствии внешнего электрического поля в таком переходе протекают следующие физические процессы. Поскольку концентрация дырок в p-области гораздо выше их концентрации в n-области, то дырки из p-области диффундируют в n-область.
Однако, как только дырки попадают в n-область, они начинают рекомбинировать с электронами, основными носителями зарядов в n-области и их концентрация по мере углубления быстро убывает. Аналогично электроны из n-области диффундируют в p-область. Если бы дырки и электроны являлись нейтральными частицами, то их взаимная диффузия привела бы к полному выравниванию концентрации дырок и электронов по всему объему кристалла, p-n-переход, как таковой, отсутствовал бы.
Встречная диффузия подвижных носителей заряда приводит к появлению в n-области нескомпенсированных положительных зарядов ионов донорной примеси, а в p-области – отрицательных зарядов ионов акцепторной примеси, связанной с кристаллической решеткой полупроводника (рис.4.1,б).
Распределение объемной плотности указанных зарядов ρоб
показано на рис. 4.1, в. Таким образом, на границе областей образуются два слоя
равных, но противоположных по знаку зарядов. Образовавшаяся область пространственных
зарядов (ОПЗ) и представляет собой p-n-переход. Его ширина обычно равна dp-n =
10-3-10-
n-области к p-области. Между p- и n-областями
устанавливается разность потенциалов UK, зависящая от материала и уровня легирования. Например, UK для германиевых p-n-переходов
составляет 0,3 ÷ 0,4 В, а для кремниевых 0,7 ÷ 0,8 В.

Рис. 4.1. Идеальный плоскостной p-n-переход:
а - отдельные p- и n-полупроводники;
б - схематическое изображение идеального плоскостного p-n-перехода;
в - распределение плотности объемных зарядов;
г - распределение потенциала;
д- распределение электронов проводимости и дырок;
+, – - ионы; «+», «–» - дырки и электроны
Так как электрическое поле неподвижных зарядов p-n-перехода при термодинамическом равновесном состоянии препятствует диффузии основных носителей заряда в соседнюю область, то считают, что между p- и n-областями устанавливается потенциальный барьер φо, распределение потенциала которого вдоль структуры p-n-перехода показано на рис. 4.1, г.
Основные носители заряда при встречной диффузии рекомбинируют в приконтактных областях p-n-перехода, что приводит к образованию в этом месте обедненного подвижными носителями заряда слоя, который обладает малой удельной проводимостью (как беспримесный или собственный полупроводник) и поэтому называется обедненным или запирающим слоем X3 (рис.4.1,д).
4.2. Вольтамперная характеристика p-n-перехода.
Зависимость тока через p-n-переход от приложенного напряжения I=f(U) есть теоретическая вольтамперная характеристика (ВАХ) p-n-перехода (рис.4.2).
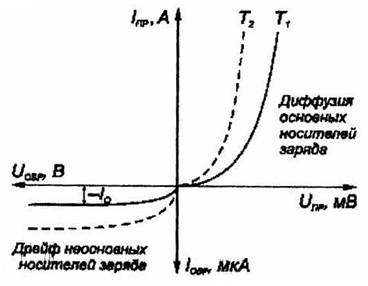
Рис.4.2. Вольтамперная характеристика p-n-перехода:
______зависимость при нормальной температуре Т1;
- - - -зависимость при повышенной температуре Т2;
Т2>Т1.
При подаче на p-n-переход обратного напряжения ток I быстро достигает значения, равного Io, и затем при повышении обратного напряжения остается практически постоянным. Так как неосновных носителей в областях p и nмало, то при обратном включении ток I, обусловленный только неосновными носителями, мал.
При подаче на p-n-переход прямого напряжения ток I с увеличением U возрастает по экспоненте. Так как основных носителей в областях pи n много, то при прямом включении обусловленный основными носителями ток будет большим.
Вольтамперная характеристика p-n-перехода существенно зависит от температуры перехода. При увеличении температуры растет концентрация неосновных носителей и резко возрастает обратный ток перехода Io. В идеальных германиевых p-n-переходах при увеличении температуры на каждые 10оС обратный ток удваивается. И хотя в кремниевых переходах зависимость еще больше, но абсолютные значения Iо у кремниевых переходов значительно меньше.
При малом прямом смещении прямой ток p-n-перехода возрастает с увеличением температуры из-за увеличения обратного тока Iо. При больших напряжениях, т.е. при больших прямых токах, основную роль играет проводимость полупроводника, которая уменьшается с увеличением температуры, поэтому прямые ветви ВАХ изменяются относительно мало.
Контрольные вопросы:
1. Что называется электрическим переходом в полупроводниковых изделиях?
2. Какие p-n-переходы Вы знаете?
3. Какие переходы называются изотипными?
4. Расскажите об идеальном плоскостном p-n-переходе.
5. Нарисуйте ВАХ для p-n-перехода.
6. Как изменяется ВАХ при повышении температуры?
7. Дайте характеристику потенциального барьера.
Глава 5. Биполярные и полевые транзисторы.
Транзистором называют активный полупроводниковый прибор, используемый для усиления или генерирования электрических сигналов.
В переводе с английского составное слово «транзистор» означает «преобразователь сопротивлений». В зависимости от принципа действия и конструктивных признаков транзисторы подразделяются на биполярные и полевые.
Биполярные транзисторы – это полупроводниковые приборы с двумя встречно-направленными p-n-переходами, созданными в одном кристалле, и тремя внешними выводами.
Полевые транзисторы – это полупроводниковые приборы, в которых изменение тока происходит под действием перпендикулярного току электрического поля, создаваемого входным сигналом.
В биполярных транзисторах ток через кристалл обусловлен движением носителей заряда обоих знаков; в полевых (часто называемых униполярными) – протекание тока через кристалл обусловлено носителями заряда только одного знака. В качестве полупроводниковых материалов для изготовления биполярных транзисторов используются преимущественно кремний, германий и арсенид галлия (GaAs).
По физическим эффектам, лежащим в основе управления носителями заряда, полевые транзисторы бывают двух видов: с управляющим p-n-переходом и со структурой металл-диэлектрик-полупроводник (МДП-транзистор). В полевых транзисторах в качестве полупроводникового материала используют в основном кремний и арсенид галлия, в качестве диэлектрика – оксид кремния SiO2 (в МОП-транзисторах) или сложные структуры, например SiO2-Al2O3, SiO2-Si3N4 и др. (в МДП-структурах).
5.1. Структура биполярных транзисторов и принцип действия.
Рассмотрим структуру биполярных плоскостных транзисторов, у которых оба перехода - плоскостные. Упрощенные структуры плоскостных p-n-p и n-p-n типов показаны на рис.5.1.
Биполярный транзистор имеет области: эмиттер, база и коллектор – два p-n-перехода.
Эмиттерный переход (на границе областей эмиттер-база) и коллекторный (на
границе областей база-коллектор). Базовая область (база Б) – область, в которую
инжектируются неосновные для этой области носители заряда. Эмиттерная область
(эмиттер Э) – область, назначение которой – инжекция носителей в базовую
область. Коллекторная область (коллектор К) предназначена для экстракции
носителей из базовой области. Принцип работы транзисторов p-n-p и n-p-n-типов
одинаков, но в транзисторе со структурой типа p-n-p основной ток, текущий через базу, создается дырками,
инжектируемыми из эмиттера, а в транзисторах со структурой n-p-n-типа - электронами.

Рис.5.1. Схематическое изображение биполярного плоскостного транзистора и его условное изображение: а) p-n-p-типа; б) n-p-n-типа; в) распределение концентраций основных носителей заряда вдоль структуры транзистора в равновесном состоянии; W- толщина базы
На условных обозначениях эмиттер изображается в виде стрелки, которая указывает прямое направление тока эмиттерного перехода (т.е. от «плюса» к «минусу»).
Если бы эмиттерный и коллекторный переходы находились на большом расстоянии друг от друга, т.е. толщина базы W была бы значительно больше диффузионной длины неосновных носителей в базе, то носители, инжектируемые эмиттером, не доходили бы до коллектора, т.к. рекомбинировали бы в базе. В этом случае каждый из переходов можно рассматривать в отдельности, не учитывая их взаимодействия, причем вольт-амперная характеристика эмиттерного перехода представляла бы прямую ветвь характеристики диода, а коллекторного перехода - обратную ветвь.
Основная особенность биполярного транзистора заключается во взаимном влиянии переходов друг на друга. В биполярных плоскостных транзисторах для эффективного влияния эмиттерного перехода на коллекторный необходимо выполнение следующих требований:
1. Толщина базы транзистора W должна
быть много меньше диффузионной длины инжектируемых в нее носителей Lб, т.е.
W= 1,5 - 25 мкм < Lб.
2. Концентрация основных носителей в базе должна быть много меньше концентрации основных носителей в области эмиттера.
3. Концентрация основных носителей в области коллектора должна быть несколько меньшей, чем в области эмиттера.
4. Площадь коллекторного перехода должна быть в несколько раз больше площади эмиттерного перехода.
Все положения, рассмотренные ранее для одного p-n-перехода, справедливы для каждого из p-n-переходов транзистора. В отсутствие внешнего напряжения наблюдается динамическое равновесие между потоками дырок и электронов, протекающими через p-n-переходы, и общие токи равны нулю.
Транзистор p-n-p-типа в активном режиме включения показан на рис. 5.1, а. Эмиттерный переход включен в прямом направлении, коллекторный - в обратном. При этом через эмиттерный переход должен протекать большой прямой ток IЭ, а через коллекторный переход – малый обратный ток коллектора.
Основные носители заряда в эмиттере – дырки – диффундируют из-за разности концентрации в базу, становясь там неосновными носителями. Процесс перехода носителей зарядов из эмиттера в базу называют инжекцией. По той же причине электроны из области базы диффундируют в область эмиттера, поэтому ток диффузии эмиттера имеет две составляющие – дырочную Iэp и электронную Iэn: Iэ= Iэp+ Iэn. Так как концентрация дырок в базе значительно меньше концентрации дырок в эмиттере, то дырочный ток Iэp преобладает над электронным током из базы Iэn, т.е. Iэp>> Iэn, поэтому можно принять, что ток базы для p-n-p-транзисторов Iб ≈ Iэp.
5.2. Полевой транзистор с управляющим p-n-переходом.
Полевой транзистор с управляющим p-n-переходом – полупроводниковый прибор, в котором ток основных носителей заряда управляется поперечным электрическим полем обратно смещенного p-n-перехода (или переходов).
Простейший полевой транзистор с управляющим p-n-переходом состоит из полупроводниковой пластины, имеющей электропроводность определенного типа, от концов которой сделаны два вывода – электроды стока (С) и истока (И), с одним (рис.5.2,а) или двумя p-n-переходами p-n-переходами (рис.5.2,б) от которого сделан третий вывод – затвор (З).
Электрод, от которого начинают движение основные носители заряда в канале, называют истоком, а электрод, к которому движутся основные носители заряда, называют стоком. На рис.5.2,в дана одна из структур выпускаемых промышленностью полевых транзисторов. Действие этих транзисторов основано на зависимости толщины пространственного заряда (ОПЗ) p-n-перехода от приложенного к нему напряжения.
При включении между истоком и стоком транзистора источника напряжения E1 (или ЕСИ) по каналу от истока к стоку потечет ток основных носителей (в данной структуре – электронов), величина которого определяется приложенным напряжением и сопротивлением канала. Если на затвор транзистора подать напряжение Е2 (или ЕЗИ) так, чтобы p-n-переход (или переходы) оказались смещенными в обратном направлении, то переход (переходы) расширяясь, уменьшают ширину канала W.
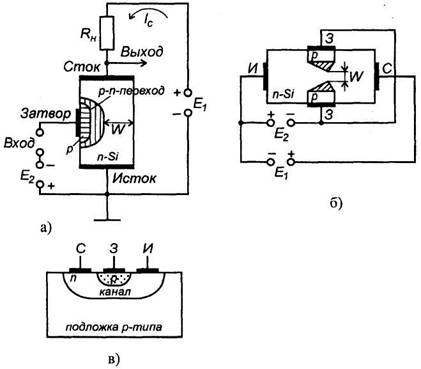
Рис 5.2. Упрощенная структура полевого транзистора: (а) - с одним управляющим p-n-переходом; (б) - с двумя управляющими p-n-переходами; (в) - типовая структура.
Уменьшение поперечного сечения канала приводят к увеличению его сопротивления и собственно к уменьшению протекающего по каналу тока.
5.3. МДП-транзисторы.
У МДП-транзисторов, в отличие от полевых транзисторов с управляющим p-n-переходом металлический затвор изолирован от полупроводника слоем диэлектрика и имеет дополнительный вывод от кристалла на котором выполнен прибор, называемый подложкой П (рис. 5.3). В этих транзисторах управляющий электрод, т.е. затвор, отделен от канала тонким слоем диэлектрика (0,05 ÷ 0,20 мкм) и допускает приложения напряжения любой полярности. Если в качестве диэлектрика применен оксид кремния, то эти транзисторы называются МОП-транзисторами (т.е. со структурой металл-оксид-полупроводник).
МДП-транзисторы по способу образования канала подразделяются на транзисторы со встроенным каналом (канал создается при изготовлении) и с индуцированным каналом (канал возникает под действием напряжения, приложенного к управляющим электродам). Важными параметрами МДП-транзистора являются длина канала L (обычно 0,1 - 5 мкм), ширина канала z (на рис. 5.3, б), толщина диэлектрика (изолятора) d с диэлектрической постоянной εi, и проводимость канала.

Рис. 5.3. Разрез
структуры МДП-транзисторов с каналом p-типа:
а - планарный транзистор со встроенным каналом; б - параметры МДП-транзистора;
в - планарный транзистор с индуцированным каналом:
1 - диэлектрик; 2 - канал
Существенным преимуществом МДП-транзисторов является высокое входное сопротивление, достигающее значений более 104 МОм вместо более 10 МОм у транзисторов с управляющим p-n-переходом.
Устройство транзистора со встроенным p-каналом схематично представлено на рис. 5.3, а. Основой является пластина слаболегированного кремния с электропроводностью n-типа. Области стока и истока обладают электропроводностью p+-типа, соединенные узкой слаболегированной областью кремния с электропроводностью p-типа, что является встроенным каналом. Затвор представляет собой металлический слой, изолированный от канала тонким диэлектриком толщиной d. В транзисторе со встроенным каналом происходит расширение или сужение имевшегося канала в результате приложения отрицательного или положительного напряжения соответственно. При положительном напряжении на затворе дырки проводимости оттесняются из области канала в объем полупроводника электропроводностью n-типа. Канал обедняется носителями заряда, сужается к стоку. При подаче на затвор отрицательного напряжения происходит обогащение дырками объема канала, он расширяется, и его проводимость возрастает.
Таким образом, изменяя напряжение на затворе, можно изменять проводимость канала, т.е. ток, проходящий через этот канал.
В транзисторах со встроенным каналом ток в цепи стока будет протекать и при нулевом напряжении на затворе. Для прекращения его необходимо к затвору приложить положительное напряжение (для случая с каналом p-типа), равное напряжению UЗИотс. При приложении отрицательного напряжения канал расширяется, и ток увеличивается.
Структура МДП-транзистора с индуцированным p-каналом показана на рис. 5.3,в. В качестве исходного материала транзистора использован кремний n-типа. Чаще всего диэлектриком используется оксид кремния SiO2. В оксиде кремния всегда содержатся положительно заряженные ионы, обусловленные такими ионизирующими примесями, как положительные ионы натрия, калия, водорода, осаждаемые на поверхность кремния в процессе выполнения технологических операций. Положительный заряд в пленке оксида кремния наводит (индуцирует) в поверхностном слое n-области слой накопления электронов, в котором концентрация электронов выше, чем в объеме n-области. При подаче на затвор отрицательного напряжения UЗИ электроны поверхностного слоя отталкиваются в глубь полупроводника, а дырки движутся к поверхности. Приповерхностный слой приобретает дырочную электропроводность, т.е. появляется тонкий инверсный слой, соединяющий сток с истоком, который играет роль канала. Толщина индуцированного канала составляет всего 1-5 нм. При приложении напряжения между истоком и стоком дырки, перемещаясь по каналу, создают ток истока. Изменяя напряжение на затворе, можно расширять или сужать канал, увеличивая или уменьшая ток стока.
5.4. Методы получения транзисторов.
P-n-переходы транзисторов получают методами сплавления, диффузии, эпитаксии, выращивания.
Планарные переходы получили
свое название потому, что
p-n-переходы
диодных или транзисторных структур и контакты по всем областям расположены на
одной плоскости полупроводникового кристалла.
Последовательность основных технологических этапов получения диффузионных транзисторов n-p-n-типа планарного типа следующая:
|
|
- исходная пластина n-типа, коллектор |
|
|
1. |
|
- диффузия бора, создающая участок p-типа, база |
|
2. |
|
- диффузия фосфором, создающая участок n-типа, эмиттер |
|
3. |
|
- создание омических контактов |
|
4. |
Резка пластины на кристаллы |
|
|
5. |
Напайка (наклейка) кристалла на основание корпуса |
|
|
6. |
Разварка внутренних выводов, соединяющих участки кристалла с траверсами корпуса. |
|
|
7. |
Герметизация корпуса |
|
|
8. |
Контроль электрических параметров. |
Проведение диффузионных процессов происходит с использованием процессов фотолитографии.
Контрольные вопросы:
1.Что называется транзистором?
2.Какие типы транзисторов Вы знаете?
3.Нарисуйте структуру биполярного плоскостного транзистора.
4.Чем отличаются транзисторы p-n-pи n-p-nтипов?
5.Какие требования необходимо соблюдать в биполярных плоскостных транзисторах?
6.Нарисуйте структуру полевого транзистора с одним управляющим p-n-переходом.
7.Нарисуйте структуру полевого транзистора с двумя управляющими p-n-переходами.
8.Расскажите о принципе работы полевого транзистора.
9.Нарисуйте разрез структуры МДП-транзистора со встроенным каналом.
10.Нарисуйте разрез структуры МДП-транзистора с индуцированным каналом.
11.Расскажите о принципе работы МДП-транзистора.
12.Что такое планарные переходы?
13.Какова последовательность основных технологических этапов получения диффузионного планарного транзистора?
Глава 6. Интегральные схемы.
6.1. Общие понятия.
Блоки и узлы радиоэлектронной аппаратуры на втором этапе развития электронной техники (после электронных ламп) строились на полупроводниковых приборах. Но возникла мысль, а можно ли отдельные блоки и узлы создать в одном корпусе на одной подложке или в одном кристалле полупроводника. Эта идея начала реализовываться в мировой промышленности с конца шестидесятых годов.
Интегральная схема (ИС) — это конструктивно законченное изделие электронной техники, выполняющее определенную функцию, и содержащее совокупность транзисторов, полупроводниковых диодов, резисторов, конденсаторов и других элементов, электрически соединенных между собой.
Теория, методы расчета и технология изготовления ИС составляют основное содержание микроэлектроники.
По технологии изготовления различают полупроводниковые (т. е. монолитные), пленочные и гибридные ИС.
В полупроводниковой ИС все элементы и межэлементные соединения выполнены в объеме и на поверхности полупроводника, обычно кремния. Как правило, для полупроводниковых ИС характерно создание всех элементов одновременно в ходе единого технологического цикла.
В пленочных ИС все элементы и межэлементные соединения выполнены в виде проводящих, диэлектрических и резистивных пленок (слоев) на подложке. Такие ИС содержат, как правило, только пассивные элементы (резисторы, конденсаторы, катушки индуктивности, межсоединения). Вариантами пленочных ИС являются тонкопленочные с толщиной пленок 1...3 мкм и менее и толстопленочные с толщиной пленок свыше 3...5 мкм. Деление пленочных ИС обусловлено не столько толщиной пленок, сколько методом их нанесения в процессе создания пассивных элементов. Пассивные элементы тонкопленочных схем наносят на подложку преимущественно с использованием термовакуумного распыления и катодного осаждения, а пассивны элементы толстопленочных схем получают нанесением и вжиганием проводящих и резистивных паст.
Наряду с полупроводниковой и пленочной широко используется гибридная технология, в которой сочетаются тонкопленочные или пассивные толстопленочные элементы с полупроводниковыми активными, называемыми компонентами гибридной схемы. Частным случаем гибридной ИС является многокристальная ИС, содержащая в качестве компонентов несколько бескорпусных полупроводниковых схем на одной подложке. Наиболее распространены в настоящее время полупроводниковые и гибридные ИС.
Число элементов в данной ИС характеризует ее степень интеграции. В соответствии со степенью интеграции все ИС условно делят на малые (МИС — до 102 элементов на кристалл), средние (СИС — до 103), большие (БИС — до 104), сверхбольшие (СБИС — до 106), ультрабольшие (УБИС — до 109) и гигабольшие (ГБИС — более 109 элементов на кристалл). Иногда степень интеграции определяют величиной k=lgN, где N — число элементов, входящих в ИС, а значение k определяется до ближайшего целого числа в сторону увеличения. Например, ИС первой степени интеграции (k= l) содержит до 10 элементов, второй степени интеграции (k= 2) — свыше 10 до 100, третьей степени интеграции (k= 3) — свыше 100 до 1000 и т. д.
При всем своем многообразии ИС по функциональному назначению делятся на два основных класса — аналоговые (частный случай — линейные) и цифровые. Аналоговые ИС предназначены для усиления, ограничения, частотной фильтрации, сравнения и переключения сигналов, изменяющихся по закону непрерывной функции.
Цифровые ИС предназначены для преобразования (обработки) сигналов, изменяющихся по закону дискретной функции (например, выраженных в двоичном или другом цифровом коде). Цифровые ИС представляют собой множество транзисторных ключей, обладающих двумя устойчивыми состояниями (разомкнутым и замкнутым). Основным видом цифровых схем являются логические ИС, выполняющие одну или несколько логических функций, простейшими из которых реализуются такие функции, как «И», «ИЛИ», «НЕ» и др.
Полупроводниковые ИС по конструктивно-технологическому принципу бывают биполярные, т. е. использующие биполярные транзисторы, и МДП, т. е. построенные на МДП-транзисторах. Кристаллом ИС называется структура, содержащая элементы, межэлементные соединения и контактные площадки (металлизированные участки, служащие для присоединения внешних выводов). В большинстве полупроводниковых ИС элементы располагаются в тонком (толщина 0,5... 10 мкм) приповерхностном слое полупроводника. Так как удельное сопротивление полупроводника невелико (1...10 Ом), а элементы должны быть изолированы друг от друга, необходимы специальные изолирующие области.
6.2. Элементы биполярных полупроводниковых ИС.
Типичная структура полупроводниковой ИС, выполненная по биполярной технологии, показана на рис. 6.1. В такой ИС отдельные элементы, сформированные в «карманах» с проводимостью n-типа, оказываются электрически изолированными друг от друга обратносмещенным p-n-переходом, для чего на подложку p-типа кремния подается отрицательный потенциал. Предварительно создаваемые локальные области (называемые «карманами») служат для исключения взаимного влияния активных и пассивных элементов и могут быть изолированы друг от друга кроме p-n-переходом диэлектриком или комбинированным методом с применением p-n-переходов и диэлектрика.
В качестве резисторов в биполярных ИС используют участки однородного полупроводника; в качестве конденсаторов — обратносмещенные p-n-переходы. Индуктивность не создается в толще полупроводника, а может наноситься в виде спирали из металла на поверхности полупроводника.
Диоды и транзисторы, используемые в ИС, изготовляют по планарной технологии, то есть их выводы находятся на одной поверхности. Планарная технология позволяет в течение единого технологического процесса получать одновременно различные элементы.
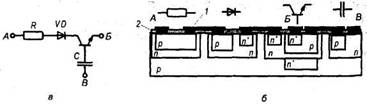
Рис. 6.1. Интегральная схема с изоляцией р-n-переходом:
а — электрическая схема; б — топология;
1 — металлическое межсоединение; 2 — слой SiO2;
А, Б, В, — соответствующие друг другу точки на рис. а и б.
При конструировании ИС стремятся применять диоды эквивалентные переходам эмиттер-база или коллектор-база транзисторной структуры. В этом случае диоды изготавливают в едином технологическом цикле с остальными элементами.
Соединение элементов в полупроводниковой ИС может осуществляться несколькими способами, основным из которых является нанесение металлических тонкопленочных проводящих дорожек (чаще всего алюминиевых), изолированных от элементов кристалла слоем диэлектрика, чаще всего оксида кремния SiO2; с помощью проволочных соединений.
Количество кристаллов ИС, получаемых в едином технологическом процессе на одной пластине, чаще всего кремния, зависит от размера кристалла, в свою очередь зависящего от количества элементов в схеме, и диаметра пластин. Площадь кристалла ИС в зависимости от ее сложности составляет 1...100 мм2, наиболее распространены размеры 10...50 мм2.
6.3. Элементы ИС на МДП-структуре.
В качестве активных элементов в ИС могут использоваться кроме биполярных полевые транзисторы со структурой «металл-диэлектрик (оксид)-полупроводник», т.е. МДП-транзисторы или МОП-транзисторы. В соответствии с этим все монолитные ИС разделяются на три основных вида: МДП ИС (МОП ИС), биполярные и биполярно-полевые ИС. МДП ИС могут быть реализованы на транзисторах с каналом p-типа (p-МДП ИС, p-МОП ИС) и каналом n-типа (n-МДП ИС, n-МОП ИС), а также на комплементарных, т. е. использующих одновременно p- и n-типы, МДП-транзисторах (КМДП ИС, КМОП ИС). Биполярно-полевые ИС представляют собой объединенные в одном кристалле биполярные и КМДП ИС (БиКМДП ИС, БиКМОП ИС).
Основными элементами современных МДП ИС являются МДП-транзисторы с каналом n-типа. Площадь этих транзисторов на кристалле значительно меньше, чем биполярных, поэтому в ИС на n-канальных МДП-резисторах достигается самая высокая (в 3-10 раз) степень интеграции, но они уступают биполярным ИС по быстродействию.
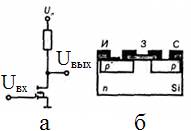
Рис.
6.2. Схема полевого транзистора с резистором:
а - эквивалентная схема; б - топология МОП-резистора
В комплементарных МДП ИС применяют МДП-транзисторы с индуцированными каналами n- и р-типа, для этих ИС характерна очень малая потребляемая мощность.
МОП-транзистор может использоваться в качестве конденсатора и резистора, при этом значение емкости и сопротивления можно изменять в определенных пределах путем изменения потенциала на управляющем электроде (т. е. на затворе).
В качестве резистора МДП-транзистор используется при Uзи=0, т. е. при этом сопротивление канала имеет наибольшее значение. Сопротивление между выводами стока и истока в этом случае обратно пропорционально отношению ширины канала b к его длине L, т. е. b/L. Эта зависимость позволяет проводить расчет топологии для получения необходимого сопротивления резистора.
На рис. 6.2 приведена схема МДП-транзистора, используемого в качестве
резистора. Структура МДП-конденсатора показана на рис. 6.3. Диэлектриком в этом
конденсаторе является термически выращенная пленка диоксида кремния SiO2. Одним
из электродов является пленка напыленного металла на SiO2, являющимся
диэлектриком, другим — сильнолегированная n+-область
кремния, лежащая под оксидом. Высокоомный n-слой и
p-кремний подложки образуют изолирующий p-n-переход.
Емкость МДП-конденсатора зависит прямо пропорционально площади и обратно
пропорциональна толщине оксидной пленки. Уменьшение толщины оксидной пленки для
получения емкости большей величины имеет ограничения, так как неоднородность
структуры очень тонкой пленки может привести к замыканию обкладок
конденсатора.
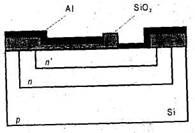
Рис.6.3. МДП-конденсатор
Изготавливают МДП ИС методами планарной технологии. Трудоемкость изготовления МДП ИС на 30% ниже, чем биполярных ИС, так как технологический цикл изготовления МДП ИС состоит из 22 основных операций, а биполярных ИС — из 32.
Контрольные вопросы:
1. Дайте определение интегральной схемы.
2. Как различают ИС по технологии изготовления?
3. Расскажите о делении ИС по степени интеграции.
4. Как различают ИС по функциональному назначению?
5. Расскажите об элементах биполярных ИС.
6. Расскажите об элементах ИС на МДП-структурах.
Глава 7. Большие интегральные схемы.
7.1. Общие положения.
Ранее говорилось, что большими интегральными схемами называют полупроводниковые ИС, содержащие более 103 элементов на кристалл.
Развитие современных технологических процессов изготовления ИС позволяет значительно уменьшать минимальные технологические размеры с одновременным увеличением размеров кристалла, т.е. создавать ИС с большой степенью интеграции, называемые большими интегральными (БИС).
БИС являются сложными схемами, реализующими узлы и целые электронные устройства. Различают монолитные и гибридные БИС. Среди монолитных БИС наибольшее распространение получили полупроводниковые БИС на основе МДП-структур, что обусловлено малыми размерами их активных элементов, а также более простой технологией изготовления по сравнению с монолитными БИС на основе биполярных структур.
По функциональному назначению различают БИС, предназначенные для использования в микропроцессорных комплектах в качестве запоминающих устройств, аналого-цифровых и цифровых преобразователей, усилителей и др. БИС являются основной элементной базой микро-ЭВМ, а также широко используются для создания ЭВМ других типов, что обеспечивает повышение их надежности, уменьшение габаритных размеров и массы, а также существенное снижение потребляемой ими мощности.
То есть по функциональному назначению БИС также могут быть цифровыми, или логическими, и аналоговыми, или линейными. К первым относятся декадные счетчики, накапливающие сумматоры, полные арифметические блоки, упоминаемые ранее запоминающие устройства и др.
Специальные БИС для ЭВМ, выполняющие не логические функции, т.е. аналоговые, имеют очень большую номенклатуру. К этим БИС можно отнести усилители записи и считывания различных запоминающих устройств (ЗУ), преобразователи уровней, времязадающие схемы, схемы стабилизаторов напряжений, дифференциальные операционные усилители, компараторы, усилители индикации и др.
Для преобразования аналоговых сигналов в цифровой эквивалент используют аналого-цифровые преобразователи (АЦП), а для обратного преобразования цифровых уровней в аналоговые — цифроаналоговые преобразователи (ЦАП).
АЦП — это электронное устройство, осуществляющее автоматическое преобразование непрерывно изменяющейся аналоговой величины в цифровой код. Процесс аналого-цифрового преобразования в общем случае включает процедуры квантования (дискретизация непрерывной величины по времени, уровню или обоим параметрам одновременно) и кодирования.
Цифроаналоговый преобразователь (ЦАП) — это электронное устройство, осуществляющее автоматическое преобразование числовых кодов в эквивалентные им значения какой-либо физической величины. Выходные физические величины чаще всего представляют собой временные интервалы электрического напряжения или тока.
Развитие техники АЦП и ЦАП осуществлялось поэтапно — от простых наборов ИС, на базе которых конструировали преобразователи, до создания БИС АЦП и БИС ЦАП по различным технологиям.
Отечественной промышленностью серийно выпускались БИС ЦАП типов: К572ПА, К572ПА1, КР572ПА2, К594ПА1, К1108ПА1, К1118ПА1, и БИС АЦП типов: К572ПВ1, К572ПВ2, К1113ПВ1, К1107ПВ1, К1107В2, К1107ПВЗ, К1108ПВ1. Указанные БИС изготовлялись по технологии МОП или биполярной с использованием транзисторно-транзисторной логики.
7.2. Микропроцессоры и микропроцессорные комплекты.
Увеличение уровня интеграции ИС и улучшение их технико-экономических характеристик позволили использовать вычислительные устройства во многих областях: от устройств промышленного оборудования и контрольно-испытательной аппаратуры до ЭВМ. Процесс применения ИС для построения различной вычислительной техники значительно ускорился с применением микропроцессоров.
Название «микропроцессор» связано с исполнением процессора на одном или нескольких кристаллах полупроводниковой ИС. Микропроцессоры служат главными функциональными частями микро-ЭВМ, которые реализуются на БИС. Подготовительным этапом развития микропроцессоров стали микрокалькуляторы. Именно на них были отработаны технологические, схемо-технологические и архитектурные решения, которые широко использовались в дальнейшем при создании первых микропроцессоров.
Микропроцессор — самостоятельное или входящее в состав ЭВМ (электронно-вычислительной машины) устройство, осуществляющее обработку информации и управляющее этим процессом, выполненное в виде одной или нескольких БИС. В общем случае в состав микропроцессора
входят: арифметико-логическое устройство (АЛУ), блок управления и синхронизации, запоминающее устройство (ЗУ), регистры и другие блоки.
АЛУ осуществляет обработку поступающей от ЗУ информации по командам программы, хранящейся постоянно в ЗУ, порядок выполнения которых определяется блоком управления и синхронизации. Исходные данные, промежуточные и окончательные результаты вычислений содержатся в ЗУ или в специальных регистрах. Часть регистров используется для организации выполнения программ.
Как БИС микропроцессоры характеризуются степенью интеграции, потребляемой мощностью, помехоустойчивостью, нагрузочной способностью активных выводов, т. е. возможностью подключения к данному микропроцессору и других ИС, технологией изготовления, типом корпуса, устойчивостью к различным внешним воздействиям.
Как вычислительное устройство микропроцессоры характеризуются производительностью, разрядностью обрабатываемых данных и выполняемых команд, возможностью увеличения разрядности, числом команд, количеством внутренних регистров, объемом адресуемой памяти, наличием и видом программного обеспечения, способом управления и др.
Микропроцессоры, используемые в средствах вычислительной техники различного назначения, называются универсальными, а предназначенные для построения какого-либо одного типа вычислительного устройства, называются специализированными. К последним относятся микропроцессоры, используемые в микрокалькуляторах.
По структуре микропроцессоры подразделяются на секционированные (как правило, с микропрограммным управлением) и однокристальные (с фиксированной разрядностью и постоянным набором команд). Секционированные микропроцессоры обладают способностью к расширению своих функциональных возможностей за счет подключения дополнительных ИС.
Однокристальный микропроцессор с фиксированной разрядностью и с постоянным набором команд конструктивно исполняются в виде одной БИС. Такой микропроцессор выполняет функции процессора ЭВМ, все операции которого определяются хранящимися в его памяти командами. Особенность однокристального микропроцессора — наличие внутренней шины, по которой происходит обмен информацией между устройствами микропроцессора.
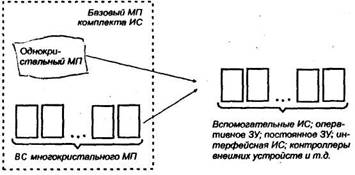
Рис. 7.1. Состав микропроцессорного комплекта интегральных схем
По функциональным возможностям микропроцессор соответствует процессору ЭВМ, выполненному на 20-40 ИС малой и средней степени интеграции, но обладает большим быстродействием, существенно меньшими размерами, массой, потребляемой мощностью.
Применение различных схемо-технологических методов при изготовлении
микропроцессоров позволяет, например, получать на основе
р-МОП-схем до 80 тыс. операций/с, n-МОП-схем
— 500...600 тыс. оп/с, КМОП-схем 400 тыс. оп./с, ЭСТЛ-схем — 3 млн. оп/с.
Совокупность конструктивно и электрически совместимых ИС, предназначенных для построения микропроцессоров, микро-ЭВМ и других вычислительных устройств с определенным составом и требуемыми технологическими характеристиками, есть микропроцессорный комплект интегральных схем.
Основа микропроцессорного комплекта интегральных схем — базовый комплект, который может состоять либо из одной БИС — однокристального микропроцессора с фиксированной разрядностью и постоянным набором команд, либо из набора ИС — многокристального секционированного микропроцессора МП (рис.7.1).
Для расширения функциональных возможностей МП базовый комплект дополняется ИС других типов, например запоминающими устройствами, интерфейсными ИС, контроллерами внешних устройств. Эти ИС могут быть одной серии с ИС базового комплекта или разных.
Контрольные вопросы:
1. Какие ИС называют большими? Их деление по конструкции, технологии и функциональному назначению?
2. Дайте определение схем АЦП.
3. Дайте определение схем ЦАП.
4. Какую схему БИС называют микропроцессором?
5. Какие микропроцессоры называют универсальными и специализированными?
6. Расскажите о микропроцессорном комплекте ИС.
Глава 8. Технологический процесс изготовления ИС.
Производственный процесс изготовления ИС можно разделить на три участка: участок формирования структур на пластине, участок сборки и участок выходного контроля.
Технологические процессы изготовления изделий в большинстве своем непрерывно-дискретные.
Непрерывные технологические процессы не могут быть прерваны до их окончания. В случае их прерывания раньше окончание процесса в большинстве случаев изделие уходит в брак. Например, аварийное отключение печей при проведении диффузионных процессов практически приводит к браку всей партии пластин.
Дискретные технологические процессы разделяются на отдельные операции. Эти процессы можно останавливать на определенное для каждого процесса время и после некоторого перерыва можно продолжать далее. Последствия такого перерыва в ходе процесса практически не отражаются на качестве изготовляемых изделий.
Технологический процесс изготовления ИС также принадлежит к непрерывно-дискретному, так как состоит из двух самостоятельных непрерывно-дискретных процессов изготовления полупроводниковых кристаллов со структурой ИС и их сборки. Изготовление структуры на кристалле включает непрерывные и дискретные процессы химической обработки пластины, процессы диффузии, литографии, напыления алюминия, разделения пластин на кристаллы. Каждый из этих процессов включает ряд технологических и контрольных операций.

Рис.8.1. Последовательность технологических операций при изготовлении ИС на пластине кремния с диэлектрической изоляцией.
Технологические метод обработки могут быть групповые и индивидуальные. Как правило, технологические процессы, связанные с обработкой пластин, являются групповыми, сборочные операции (пайка кристалла на основание корпуса, приварка внутренних выводов, герметизация и др.) – индивидуальные.
Современные технологические процессы изготовления ИС очень сложны.
Анализ процессов изготовления показывает, что они проводятся при температурах,
изменяющихся в диапазоне от – 100оС(криогенное травление) до +1100оС
(окисление, диффузия, отжиг после ионной имплантации и др.), при давлении от
атмосферного до 10-
Контрольные вопросы:
1. На какие три участка можно разделить производственный процесс изготовления ИС?
2. Дайте пояснение непрерывно-дискретному процессу изготовления ИС.
3.Привидите пример групповых и индивидуальных технологических процессов.
4. Расскажите о последовательности технологических операций изготовления структур ИС на пластине кремния.
Глава 9. Гибридные интегральные схемы.
Исторически первыми (в середине шестидесятых годов прошлого века) были разработаны гибридные ИС. В этих схемах пассивные элементы (резисторы, конденсаторы) и все соединения изготавливаются из пленок различных материалов, нанесенных на диэлектрическую подложку, а в качестве активных элементов применяются бескорпусные или в малогабаритном корпусе полупроводниковые приборы и ИС.
Гибридные БИС позволяют создавать целые электронные устройства, которые практически невозможно создавать в монолитном исполнении. К основным недостаткам гибридных БИС относятся: меньшая, чем у монолитных БИС, плотность упаковки элементов, которая приводит к увеличению размеров и массы БИС, меньшая надежность из-за сравнительно большого числа сварных соединений.
Диэлектрические подложки изготовляют из керамики, ситала или стекла. Индуктивные катушки и конденсаторы большой емкости, как правило, применяют навесные.
При изготовлении гибридной схемы сначала создают соединения, для чего напыляют или наносят каким-либо другим способом полоски алюминия, серебра или золота. После этого напыляют сопротивление из тантала, хрома или специальных сплавов. Выбирая соответствующий материал, его толщину и площадь, подбирается необходимый номинал резистора. Необходимо отметить, что сопротивление резисторов можно «подгонять» до необходимой величины частичным удалением резистивной пленки. Таким образом, эти резисторы позволяют получить непрерывную шкалу номиналов. Для изготовления конденсатора напыляется металл, затем диэлектрик и снова металл. Как и резисторы, пленочные конденсаторы имеют непрерывную шкалу номиналов емкости.

Рис.
9.1. Гибридная интегральная схема типа ГК-19:
а — после герметизации; б — до герметизации
Считается целесообразным изготовлять пленочные конденсаторы с емкостью в пределах 100-5000 пФ. Пленочные индуктивности выполняют нанесением на диэлектрические подложки пленок в виде однослойных спиралей круглой или прямоугольной формы, заканчивающихся контактными площадками. Затем устанавливают навесные элементы: диоды, транзисторы и другие элементы.
Гибридные ИС, в которых в качестве навесных элементов применены бескорпусные ИС, называют многокристальными.
Преимущества гибридно-пленочной технологии заключаются в высокой гибкости, т.е. в возможности выбора различных материалов и методов изготовления пленочных элементов, сравнительной простоте разработки и изготовления большинства схем в гибридном исполнении.
Как и полупроводниковые ИС гибридные ИС на заключительном этапе подлежат корпусированию. Перед герметизацией контактные площадки платы гибридной схемы соединяются с помощью проволоки с контактными площадками выводов корпуса, проволочные выводы развариваются или напаиваются к контактным площадкам (рис.9.1).
Контрольные вопросы:
1. Какие преимущества и недостатки гибридных схем?
2. Расскажите о последовательности технологических операций создания гибридных схем.
3. Какие гибридные схемы называются многокристальными?
Глава 10. Методы обеспечения качества и надежности в процессе серийного производства ППИ.
10.1. Общие понятия.
Для изготовителей ППИ важнейшим показателем качества служит процент выхода годных. Это объясняется тем, что выход годных изделий определяет в комплексе управляемость и стабильность производства, что, в свою очередь, связано с показателем надежности изделий.
При производстве хорошо разработанное изделие может быть некачественно, некорректно изготовлено, либо изготовлено из некачественных материалов, некачественным инструментом. Некачественное изделие может быть обнаружено производственной системой контроля качества, либо не обнаружено, или обнаружено, но пропущено ею.
В рамках работ по повышению качества большинство изготовителей полупроводниковых изделий во всем мире с начала 1982 года для измерения уровня качества продукции стали использовать такой показатель качества, как количество дефектных изделий на 1млн из всего количества изготовляемых изделий данного типа. Например, в Японии качество ППИ должно удовлетворять следующим требованиям: для полупроводниковых приборов количество дефектных на миллион полученных не должно превышать 10, для ИС малой и средней степени интеграции – 100, для БИС – 1000.
При оценке ППИ используются понятия, характеризующие запасы по тому или иному электрическому параметру по отношению к нормам технических условий. Запасы по электрическим параметрам определяются конструктивными данными и особенностями технологии производства, поэтому используют понятие конструктивно-технологического запаса.
Показатель «ритмичность выпуска изделий» характеризует в определенной степени и качество выпускаемых изделий. Как показали наблюдения, количество дефектов (нарушений технологического процесса) при неритмичной работе в конце месяца может возрасти в 3-5 раз по сравнению со средним значением.
Если практически качество ППИ оценивается данными по входному и выходному контролю на соответствие их требованиям технических условий по электрическим параметрам, то надежность изделий связана с временам сохранением своих параметров в условиях эксплуатации, включая в это понятие и длительное хранение.
Встречающееся мнение о том, что надежное изделие можно изготавливать на ненадежном устаревшем оборудовании, практически не подтверждается. Из-за экономических соображений нередко используют устаревшие технологические процессы, ошибочно считая, что контроль и испытание позволяет получить готовые изделия требуемого качества и надежности.
Предположим, что надежность ИС после его изготовления Р равна надежности схемы, заложенной при конструировании Ро. При этом всякое отклонение в технологическом процессе, в материалах, допусках, чаще всего встречающееся в начале серийного производства, снижает надежность получаемой ИС на величину ∆Р.
Но если в процессе серийного изготовления было внедрено новое конструктивно-технологическое решение, направленное на повышение качества и надежности изделий, проведена замена оборудования на новое с меньшими допусками или внедрена автоматизация технологического процесса и т.п., то надежность выпускаемых изделий может быть повышена на величину ∆Р относительно величины Ро. Тогда в общем случае для серийно выпускаемых ИС величина надежности равна:
Р
= Ро  ∆Р
∆Р
Данное положение является основой для работы над повышением надежности ИС в процессе их серийного производства.
Оптимизация конструкции и технологии ИС невозможна без использования данных о надежности, поэтому можно говорить о взаимосвязанной совокупности трех факторов: проектирования, изготовления и надежности (рис.10.1).

Рис.10.1. Треугольник (конструкция – технология – надежность) иллюстрирует взаимосвязь между процессом проектирования, изготовления и надежности ИС
В настоящее время идет процесс замены пластин диаметра
Управляемость и стабильность технологического процесса характеризуют его надежность за данный промежуток времени. Управляемость технологического процесса зависит от точности и воспроизводимости отдельных технологических операций.
Функционирование многооперационных технологических процессов производства ППИ сопровождается случайными возмущениями, выражающимися в отклонении показателей. Очевидно, чем позже на стадии производства обнаруживается отклонение этих показателей, тем к большим технологическим потерям это ведет. Чтобы избежать этого, в управляемом технологическом процессе применяется активный метод контроля.
При изготовлении ППИ имеют дело с партиями ограниченного объема, поэтому для получения необходимой информации вводится стопроцентный контроль изделий на ряде основных операций, что дает возможность по абсолютным значениям параметров изделий судить об управляемости и стабильности технологических процессов.
Активный метод контроля предполагает после выяснения причин отклонения процесса от оптимального обязательную обратную связь воздействия на технологический процесс в целях его регулирования или ликвидации нарушений. Поэтому наибольшую надежность обеспечивают регулируемые технологические процессы, в которых имеется возможность обратного воздействия на них по результатам выходных испытаний. Технологический процесс необходимо осуществлять так, чтобы исключить влияние оператора на надежность изготавливаемых изделий.
10.2. Система получения и использования информации при проведении работ по повышению надежности ППИ.
Опыт работы в электронной промышленности позволил разработать систему получения и использования информации при проведении работ по повышению надежности ППИ.

Рис.10.2. Система получения и использования информации при проведении работ по повышению надежности в процессе их серийного производства
10.3. Требования по обеспечению и контролю качества ИС в процессе производства.
В отечественной электронной промышленности существуют директивные документы, которые определяют общие требования к обеспечению качества в процессе производства.
Например, для ИС эти требования сформулированы следующим образом.
На предприятии-изготовителе ИС должны действовать документы, устанавливающие:
a)порядок обучения и аттестации производственного персонала, участвующего в изготовлении и контроле качества ИС по всему технологическому процессу;
b)порядок проверки производственного оборудования, периодичность проверки и, в необходимых случаях, методы его проверки;
c)порядок проверки выполнения требований, предъявляемых к производственным помещениям и рабочим местам (запыленность, влажность, температура, агрессивность среды);
d)порядок проверки технологического процесса;
e)порядок учета, хранения, обращения конструкторской и технологической документации;
f) порядок и методы входного контроля поступающих материалов, полуфабрикатов, комплектующих изделий;
g)порядок проведения анализа дефектных ИС и осуществления мероприятий по устранению причин их появления;
h)порядок организации анализа и учета технологических потерь в производстве;
i) порядок анализа рекламаций и согласования мероприятий, внедряемых в производство по результатам анализа.
В составе технологического процесса должны быть предусмотрены 100%-ные отбраковочные испытания. Перечень обязательных отбраковочных испытаний предусматривается в общих технических условиях на ИС.
Нормы на электрические параметры, устанавливаемые в технологической документации для проверки собранных в копус ИС, кроме функционального контроля, должны быть более жесткими в сравнении с нормами, устанавливаемыми в технологических условиях на ИС конкретных типов.
10.4. Технологические методы повышения надежности ИС в процессе серийного производства.
Процесс изготовления ИС, как правило, делится на три участка: участок формирования структур на пластине, участок сборки и финишный участок, т.е. участок выходного контроля.
Система бездефектного изготовления изделий в большей степени является организационной и не исключает, например, для ИС технических, физико-химических несовершенств технологических операций и процессов. Поэтому широко распространены технологические методы повышения надежности ИС в процессе серийного производства (рис.10.3).

Рис.10.3. Схема реализации технологических методов повышения надежности ИС в процессе серийного производства
Среди многочисленных способов энергетического воздействия на физико-химическую систему кристалла ИС основное место занимает тепловое воздействие, которое практически используется при проведении всех технологических процессов ИС (кроме фотолитографии и травления).
Одним из основных путей повышения надежности ИС является снижение температуры и использование нетермической активации основных физико-химических процессов технологии изготовления.
Например, существенные преимущества дает применение когерентных излучений, обеспечивающих высокую селективность воздействия лишь на отдельные участки. Подобное воздействие осуществляется излучением как в УФ-, так и в ИК-области спектра, а также комбинированным воздействием в обеих областях.
Технологический процесс изготовления ИС состоит из более ста операций. Каждая технологическая операция необходима для последовательного получения структур ИС и схемы в сборе.
Наряду с необходимым положительным качеством технологическая операция может вносить и отрицательные качества, на устранение которых зачастую направлены последующие технологические операции. Но известны технологические процессы, где отрицательные влияния технологической операции на процесс выхода годных, структуру и электрические параметры компенсируются в процессе проведения данной операции. Например, введение хлорсодержащей добавки в инертную атмосферу на операции разгонки при двухстадийной диффузии фосфора приводит к уменьшению дефектности структуры и снижению токов утечки изделий.
Технологию, в которой в процессе проведения технологической операции одновременно проводитсяпроцесс, направленный на устранение или значительное снижение отрицательных последствий данной операции на изделие, будет называть компенсирующей технологией.
Как видно из рис 10.3, к технологическим методам повышения надежности ИС относится также применение отбраковочных испытаний и альтернативных методов отбраковки потенциально ненадежных изделий. Эти два метода относятся к методам повышения надежности выпускаемых партий ИС, так же как и метод выравнивающей технологии. Снижение температуры технологических операций и применение компенсирующей технологии относятся к методам повышения надежности каждого выпускаемого изделия.
Контрольные вопросы:
1. Какой показатель качества существует в настоящее время в мировой практике для полупроводниковых изделий?
2. Расскажите, как влияет ритмичность выпуска изделий на качество изделий.
3.
Поясните Р = Ро
 ∆Р
∆Р
4. Расскажите об активном методе контроля технологического процесса изготовления ППИ.
5. Поясните схему системы получения и использования информации при проведении работ по повышению надежности ППИ в процессе их серийного производства.
6. Назовите основные требования по обеспечению качества ИС.
7. Нарисуйте схему реализации технологических методов повышения надежности ИС в серийном производстве.
8. Какие технологические методы относятся к методам повышения надежности партий ИС, а какие – к каждой выпускаемой схеме.
Содержание
Глава 1. Исторический обзор развития микроэлектроники. 2
1.1. Основные направления развития электроники. 2
1.2. История развития микроэлектроники. 3
Глава 2. Общие сведения о полупроводниках. 5
2.1. Полупроводники и их электрофизические свойства. 5
2.2. Структура полупроводниковых кристаллов. 7
2.3. Свободные носители зарядов в полупроводниках. 10
2.4. Элементы зонной теории твердого тела. 12
Глава 3. Методы получения монокристаллов кремния. 16
3.1. Метод Чохральского. 16
3.2. Метод зонной плавки. 16
Глава 4. Электронно-дырочный переход. 18
4.1. Образование p-n-перехода. 19
4.2. Вольтамперная характеристика p-n-перехода. 21
Глава 5. Биполярные и полевые транзисторы. 23
5.1. Структура биполярных транзисторов и принцип действия. 23
5.2. Полевой транзистор с управляющим p-n-переходом. 25
5.3. МДП-транзисторы. 26
5.4. Методы получения транзисторов. 28
Глава 6. Интегральные схемы. 30
6.1. Общие понятия. 30
6.2. Элементы биполярных полупроводниковых ИС. 31
6.3. Элементы ИС на МДП-структуре. 31
Глава 7. Большие интегральные схемы. 35
7.1. Общие положения. 35
7.2. Микропроцессоры и микропроцессорные комплекты. 36
Глава 8. Технологический процесс изготовления ИС. 39
Глава 9. Гибридные интегральные схемы. 41
Глава 10. Методы обеспечения качества и надежности в процессе серийного производства ППИ. 43
10.1. Общие понятия. 43
10.2. Система получения и использования информации при проведении работ по повышению надежности ППИ. 45
10.3. Требования по обеспечению и контролю качества ИС в процессе производства. 46
10.4. Технологические методы повышения надежности ИС в процессе серийного производства. 47
Вопросы контрольной работы по курсу «Введение в микроэлектронику».50
Литература 53
Вопросы контрольной работы по курсу «Введение в микроэлектронику».
1.
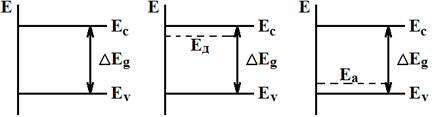
а) б) в)
На каком рисунке представлена зонная диаграмма собственного полупроводника?
2.

На каком рисунке представлена зонная диаграмма кремния, на каком – германия?
3.

Какая вольтамперная характеристика принадлежит Ge, какая – Si?
4.

Какая вольтамперная характеристика снята при повышенной температуре?
5.
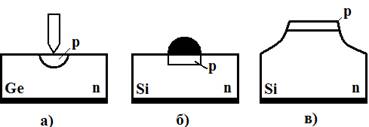
На каком рисунке показана структура сплавного, диффузионного и точечного диода?
6.

Расставьте на условном
обозначении электроды транзистора (эмиттер, коллектор, база). На каком рисунке
условно показан p-n-p-транзистор, а
на каком –
n-p-n-транзистор?
7.

а) б)
На каком разрезе структуры МДП-транзисторов показан транзистор с индуцированным каналом, на каком – со встроенным каналом?
8.
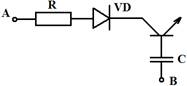
По электрической схеме нарисуйте структуру ИС с изоляцией p-n-переходом (в разрезе).
9. ИС типа КР1005ВЕ1 содержит 3000 элементов, ИС типа 106ЛБ1 содержит 18 элементов. Какая из этих схем относится к схемам средней степени, какая к БИС?
10. На каком жизненном
цикле ИС реализуется требование Р = Ро  ∆Р?
∆Р?
Литература
1.Ефимов И.Е., Козырь И.Я., Горбунов Ю.И. Микроэлектроника. Физические и технологические основы, надежность: Учебное пособие – М.: Высшая школа, 1986.-464с.
2.Готра З.Ю. Технология микропроцессорных устройств: Справочник – М.: Радио и связь, 1991.-528с.
3.Балашов Ю.С., Горлов М.И. Физические основы функционирования интегральных устройств микроэлектроники. Учебное пособие. - Воронеж: ВГТУ, 2002.-160с.
4.Горлов М.И., Ануфриев Л.И. Обеспечение и повышение надежности полупроводниковых изделий в процессе серийного производства. - М.: Бесптринт, 2003.-202с.



