Вторично-ионная масса спектрометрия
| Загрузить архив: | |
| Файл: 240-0803.zip (401kb [zip], Скачиваний: 153) скачать |
Калужский Филиал
Московского Государственного
Технического Университета
им. Н. Э. Баумана
Кафедра Материаловедения и Материалов Электронной Техники
КУРСОВАЯ РАБОТА
по курсуМИМ и КЭТ
на тему:
“Вторично-ионная
масс-спектрометрия“
выполнил:студент гр. ФТМ—81
Тимофеев А. Ю.
проверил: Леднева Ф. И.
г. Калуга
1997 год.
Содержание
Введение 3
Взаимодействие ионов с веществом 3
Вторично-ионная эмиссия 5
Оборудование ВИМС. 8
Принцип действия установок. 9
Установки, не обеспечивающие анализа распределения частиц по поверхности 10
Установки, позволяющие получать сведения о распределении 11
элемента по поверхности, со сканирующим ионным зондом
Установки с прямым изображением 11
Порог чувствительности 12
Анализ следов элементов 14
Ионное изображение 16
Требования к первичному ионному пучку 17
Масс-спектрометрический анализ нейтральных 18
распыленных частиц
Количественный анализ 19
Глубинные профили концентрацииэлементов 22
Приборные факторы, влияющие на разрешение 23
по глубине при измерении профилей концентрации
Влияние ионно-матричных эффектовна разрешение 25
по глубине при измерении профилейконцентрации
Применения 26
Исследование поверхности 26
Глубинные профили концентрации 27
Распределение частиц по поверхности, 27
микроанализ и объемный анализ
Заключение 27
Список
литературы
29
Введение
Возможности получения сведений о составе внешнего атомного слоя твердого тела значительно расширялись всвязи с разработкой и усовершенствованием метода вторично-ионной масс-спектрометрии (ВИМС) и других методов. Большинство таких методов близки к тому, чтобы анализировать саму поверхность, поскольку основная информация о составе материала поступает из его приповерхностной области толщиной порядка 10А, а чувствительность всех таких методов достаточна для обнаружения малых долей моноатомного слоя большинства элементов.
Взаимодействие быстрых ионов с твердым телом приводит к выбиванию атомов и молекул материала как в нейтральном, так и в заряженном состоянии. На таком явлении сравнительного эффективного образования заряженных частиц (вторичных ионов) и на принципе высокочувствительных масс-спектрометрических измерениях и основан метод ВИМС. Хотя у него, как у любого другого метода, имеются свои недостатки, только он один дает столь широкие возможности исследования и поверхности, и объема твердого тела в одном приборе. Наиболее важными характерными особенностями метода, которые вызывают повышенный интерес к нему, являются очень низкий порог чувствительности для большинства элементов (меньше 10-4 моноатомного слоя), измерение профилей концентрации малых количеств примесей с разрешение по глубине меньше 50А, разрешение по поверхности порядка микрометра, возможность изотопического анализа и обнаружение элементов с малыми атомными номерами (H, Li, Be и т. д.)
Взаимодействие ионов с веществом

Фиг.1. Виды взаимодействий ионов с твердым телом [2].
В этом разделе рассматривается поведение ионов высоких энергий (1 - 100 кэВ), попадающих на поверхность твердого тела. Фиг.1 иллюстрирует 10 разновидностей взаимодействияионов с поверхностью [2]. Падающий ион может обратно рассеиваться атомом или группой атомов бомбардируемого образца (1). Процесс обратного рассеяния обычно приводит к отклонению траектории иона от первоначального направленияпосле столкновения и к обмену энергией между ионом и атомом мишени. Обмен энергией может быть упругим и неупругим в зависимости от типа взаимодействующих частиц и энергии иона.
Импульс иона может быть достаточно велик для того, чтобы сместить поверхностный атом из положения, где он слабо связан с кристаллической структурой образца, в положение, где связь оказывается сильнее (2). Этот процесс называется атомной дислокацией. Ионы с более высокими энергиями могут вызывать внутренние дислокации в толще образца (3). Если соударяющиеся с поверхностью образца ионы передают настолькобольшой импульс, что полностью освобождают от связей один или несколько атомов, происходит физическое распыление (4).Ионы могут проникать в кристаллическую решетку и захватываться там, израсходовав свою энергию (ионная имплантация) (5).В результате химических реакций ионов споверхностными атомами на поверхности образуются новыехимическиесоединения, причем самыйверхний слойатомов может оказатьсявгазообразном состоянииииспариться (химическоераспыление) (6). Бомбардирующие положительныеионы врезультатепроцессса оже-нейтрализациимогутприобретать наповерхностиэлектроны и отражаться от нее в виде нейтральныхатомов(7). Ионымогутоказаться связаннымисповерхностью образца(адсорбированными) (8). При ионной бомбардировке металлическихповерхностей вопределенных условиях возможно возникновение вторичной электроннойзмиссии (9).Наконец, если поверхностные атомы возбуждаются до ионизированныхсостояний и покидают образец, имеетместо вторичная ионная эмиссия (10).
Замедляясь, ион передает энергию твердому телу. При анализе процессов потери энергии удобно различать два основных механизма: соударения с электронами и соударения с ядрами.
Первыймеханизм состоит в том, что быстрый ион взаимодействует с электронами кристаллической решетки, в результатечего возникают возбуждение и ионизация атомов кристалла. Поскольку плотность электронов в веществе мишени высока и такие столкновения многочисленны, этот процесс,
как и в случае потери энергии электронами, можно считатьнепрерывным .
Врамках второгомеханизмавзаимодействиепроисходит между экранированными зарядами ядер первичного иона иатомамимишени. Частота таких столкновений ниже, поэтомуих можно рассматривать как упругиестолкновения двухчастиц. Ионы высокихэнергийхорошо описываютсярезерфордовскимрассеянием, ионысредних энергий- экранированнымкулоновским рассеянием, однако при малыхэнергиях характервзаимодействия становится более сложным.
Кроме перечисленных выше механизмов вклад в энергетические потери дает обмен зарядами между движущимся иономи атомоммишени. Этот процесс наиболееэффективен, когда относительнаяскоростьиона сравнима с боровской скоростью электрона ( ~106 м/с) .
Такимобразом, полныепотериэнергии - dЕ/dzможно представить в виде суммы трехсоставляющих -ядерной, электроннойи обменной.
При малых энергиях ионов преобладает взаимодействие с ядрами, которое приводит к появлению угловой расходимостипучка. При высоких энергиях более существенными становятся столкновения с электронами. Справедливо следующее эмпирическое правило: передача энергии кристаллической решетке осуществляется в основном за счет ядерных столкновений при энергиях меньше А кэВ, где А - атомный вес первичного иона. В промежуточном диапазоне энергий вклад потерь, обусловленных обменом заряда, может возрастать примерно до 10% от полных потерь. Зависимость энергетических потерь от энергиипервичного иона показана на фиг.2.

Фиг.2. Зависимость энергетических потерь иона от энергии [2].
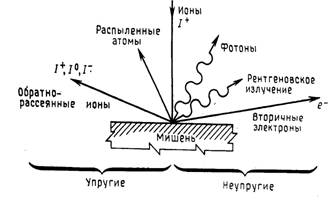
Фиг.3. Схематическое представление взаимодействия ионов с мишенью [2].
Неупругие взаимодействия с электронами мишени вызывают вторичную электронную эмиссию, характеристическое рентгеновское излучение и испускание световых квантов. Упругие взаимодействия приводят к смещению атомов кристаллической решетки, появлению дефектов и поверхностному распылению. Эти процессы схематически проиллюстрированы на фиг. 3.
Энергетический спектр рассеянных твердотельной мишенью ионов с начальнойэнергией Е0 схематическипредставлен на фиг.4. Здесь видны широкий низкоэнергетический (10 - 30 эВ) горб, соответствующий испусканию нейтральных атомов (распыленные атомы), и высокоэнергетический горб, расположенный вблизи энергии первичного иона Е0 (упругорассеянные ионы).
Вторично-ионная эмиссия
Основныефизические иприборные параметры, характеризующиеметодВИМС, охватываютсяформулами(1) - (3). Коэффициент вторичной ионной эмиссии SА±,т. е. число (положительныхили отрицательных)ионов наодин падающий ион, для элемента А в матрице образца дается выражением
SА±=gА±САS, (1)
где gА±-отношение числавторичныхионов (положительных или отрицательных) элемента А к полному числу нейтральных изаряженныхраспыленных частицданногоэлемента, а СА-атомная концентрация данногоэлемента вобразце. Множитель S -полный коэффициент распыления материала(число атомов на один первичный ион).В него входят всечастицы, покидающиеповерхность, какнейтральные, таки ионы. Величины gА±и S сильно зависят от состава матрицы образца, поскольку отношение gА± связано с электронными свойствами поверхности, а S в большойстепени определяетсяэлементарными энергиями связи или теплотой атомизации твердого тела. Любой теоретический способ пересчетаизмеренного выхода вторичных ионов ватомные концентрациидолжен, даватьабсолютное значение отношения gА± илинабор его приведенных значенийдля любойматрицы.
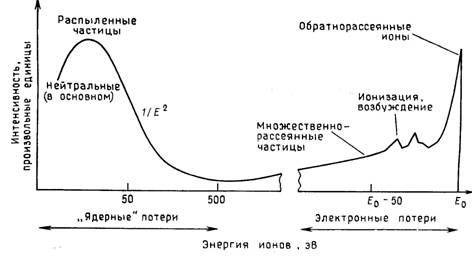
Фиг.4. Энергетический спектр электронов, рассеянных при соударении с твердотельной мишенью [2].
Вторичный ионный токiА± (числоионов в секунду), измеряемый в приборе ВИМС, дается выражением
iА± =hASA±IP,(2)
где iА±- ионный ток для моноизотопного элемента (для данного компонента многоизотопного элемента ионныйток равен faiА±, где fa,- содержание изотопа а в элементе А). Величина hA -эффективность регистрации ионов данного изотопа в используемом приборе ВИМС. Она равна произведению эффективности переноса ионов через масс-анализатор на чувствительность ионного детектора. Множитель hA обычно можно рассматривать как константу, не зависящую от вида элемента илимассы изотопа, если энергетические распределения вторичныхионов примерно одинаковы и имеют максимум при нескольких электрон-вольтах, так что зависящее от массы изменение чувствительности детектора частиц мало. Наконец, IP полный токпервичных ионов (число ионов в секунду), падающих на образец.
Конечно, величина IP связана с плотностью тока первичных ионов DP (число ионов за секунду на 1 см2) и диаметром пучка d (см). Если для простоты принять, что сечение пучка круглое, а плотность DP тока постоянна в пределах сечения, то
IP=(0,25p)DPd2.(3)
Присуществующих источникахпервичныхионов, используемых в приборах ВИМС, плотность тока наобразец, как правило, не превышает 100мА/см2 (вслучае однозарядныхионов ток 1 mАсоответствует потоку 6.2 1015 ион/с). В табл. 1 приводятся типичные значения параметров, входящих в формулы (1) - (3).
Таблица 1.
Типичные значения параметров
в формулах (1)- (3) [1].
|
gА± |
10-5¸10-1 |
|
S |
1¸10 |
|
hA |
10-5¸10-2 |
|
DP |
10-6¸10-2 mA/cm2 |
|
d |
10-4¸10-1 cm |
Самое важное значение в вопросе о возможностях ВИМС как метода анализа поверхностей имеет взаимосвязь между параметрами пучка первичных ионов,скоростью распыленияповерхностии порогомчувствительностидля элементов. Из-заотсутствия информации отакой взаимосвязичасто возникают неправильные представления о возможностях метода. Соотношения между током первичных ионов, диаметром и плотностьюпучка, скоростью распыления
поверхности и порогом чувствительности при типичных условиях иллюстрируются графиком, представленным на фиг.5. Скорость удаления (число монослоев в секунду) атомов мишени при заданной энергии ионов пропорциональна плотности их тока DP, а порог чувствительности при регистрации методом ВИМС (минимальное количество элемента, которое можно обнаружить в отсутствие перекрывания пиков масс-спектра) обратно пропорционален полному току ионов IP. Коэффициент пропорциональности между порогом чувствительности ВИМС и IP определяется исходя из результатов измерений для ряда элементов в различных матрицах путем приближенной оценки, основанной на экспериментальных значениях для типичных пар элемент - матрица. При построении графика на фиг.5 предполагалось, что площадь захвата анализатора, из которой вторичные ионы отбираются в анализатор, не меньше сечения пучка первичных ионов. Данное условие обычно выполняется в масс-спектрометрии, если диаметр области, из которой поступают ионы, не превышает 1 мм.
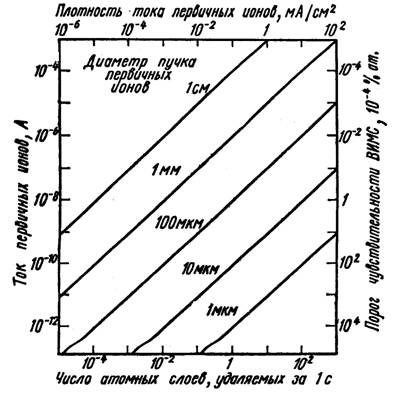
Фиг. Зависимость между током первичных ионов, диаметром и плотностью первичного
пучка, скоростью удаления атомных слоев и порогом чувствительности ВИМС[1].
Распыление ионным пучком - разрушающий процесс.Ноесли требуется, чтобыповерхность оставаласьпрактически безизменения, тоанализметодом ВИМСможно проводить приоченьмалых скоростях распыленияобразца (менее10-4 монослоя в секунду) . Чтобы приэтом обеспечитьдостаточную чувствительность метода ( »10-4монослоя), каквидно из фиг.5,необходим первичный ионный пучок с током 10-10 Адиаметром 1 мм.Пристоль низкой плотноститокапервичных ионов( 10-5мА/см2) скоростьпоступления наповерхность образца атомовили молекулостаточныхгазов можетпревысить скоростьих распыленияпервичным пучком. Поэтому измеренияметодомВИМС втакихусловиях следует проводитьв сверхвысоком или чистом (криогенном) вакууме.
Указанныеприборные условияприемлемынево всех случаяханализа.Например, определение профиля концентрациипримесей,присутствующихв малых количествахв поверхностной пленкетолщиной свыше5ОО А, удобно проводитьпри диаметре пучка, равном 100 мкм, ипри скоростираспыления, превышающей10-1атомных слоеввсекунду. Еще более высокиеплотности ионного токатребуются, чтобыобеспечить статистическизначимые количествавторичныхионов с единицы площадиповерхности,необходимые приисследовании распределения по поверхности следов элементов при помощи ионного микрозонда или масс-спектрального микроскопа. На основании сказанного и данных фиг.5 мы заключаем, что невозможнообеспечить поверхностноеразрешение внесколько микрометров для примеси, содержание которой равно »10-4%,при скорости распыления менее 10-3 атомных слоев в секунду. Это взаимно исключающие условия.
Методом ВИМС анализ поверхности можно проводить в двух разных режимах: при малой и большой плотности тока, распыляющего образец. В режиме малой плотности распыляющего тока изменяется состояние лишь малой части поверхности, благодаря чему почти выполняется основное требование, предъявляемое к методам анализа самой поверхности. В режиме же высоких плотностей токов и соответствующих больших скоростейраспыления проводится измерение профилей распределения элементов по глубине, микроанализ и определение следовых количеств элементов (<10-4%). В соответствии со всеми этими вариантами создан ряд приборов ВИМС, в которых применяются разные способы создания и фокусировки первичных ионных пучков и разные анализаторы вторичных ионов.
Оборудование ВИМС.
УстановкаВИМСсостоит из четырехосновных блоков:источникапервичных ионови системы формирования пучка,держателя образца ивытягивающей вторичныеионы линзы, масс-спектрометра для анализа вторичных частиц по отношениюмассык заряду(m/е) и высокочувствительной системырегистрацииионов. Дляполучения первичных ионов вбольшинстве установок используются газоразрядные или плазменныеисточники. Совместно с соответствующейсистемой формированияитранспортировки пучка эти источники обеспечивают широкие пределыскоростираспыления поверхности- от10-5 до103 А/с. Разделениевторичных частицпо m/е производится либомагнитными, либо квадрупольными анализаторами. Наиболее широко распространенным анализатором в установках ВИМС,очень удобным прианализе составаобразцов и обнаружениималыхколичеств (следов)элементов в них, являетсямагнитный спектрометрсдвойной фокусировкой(в котором осуществляется анализпо энергиии по импульсу), чтосвязано сего высокой чувствительностью к относительному содержанию. Для таких многоступенчатых магнитных спектрометров фоновыйсигнал, возникающийиз-за хвостов основных пиковматериала матрицы(рассеяниестенками, наатомахгаза и т.д.),может бытьсведенк уровнюменее10-9для общего фона ивсего 10-6 для масс,близкихк основномупику.Все же в отдельныхконкретных случаях более практичнымможет оказатьсяменеедорогой квадрупольный анализатор.
Принцип действия установок.
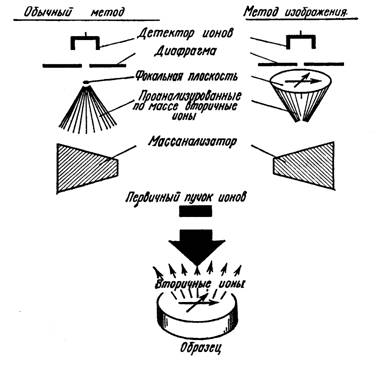
Фиг.6. Схема обычного метода и метода прямого изображения при
масс- спектрометрическом анализе вторичных ионов[1].
При масс-анализе вторичных ионов применяются два основных метода: обычный масс-спектрометрический и метод прямого изображения. Они схематически сопоставлены на фиг.6. При первом методе анализаторс хорошим разрешением передает на высокочувствительный ионный детектор заметную часть быстрых вторичных ионов, идущих с большой площади образца (» 1 мм2). Выделенные по массе вторичные частицы собираются в точечный фокус на входной щели детектора. В этом статическом случае получаемая информация усредняется по поверхности образца и невозможно установить, из какой точки (например области диаметром 1 мкм) поверхности приходят вторичные ионы. При методе прямого изображенияв фокальной плоскости анализатора создается стигматическое ионное изображение поверхности и путем соответствующего дифрагмирования (или преобразования изображенияпри помощи чувствительной к электронам или ионам эмульсии) легко можно получить информацию о точках выхода ионов с данными m/e с поверхности образца.
Все установки с прямым изображением основан на идее прибора Кастэна и Слодзяна; все иные приборы представляют собой варианты обычной масс-спектрометрической методики. Для получения вторично-ионного изображения поверхностипри обычном подходе необходимо проводить последовательный анализ вторичных частиц при сканировании поверхности
мишени первичным ионным пучком малого диаметра. При этом для получения изображения мишени на экране электронно-лучевой трубки (ЭЛТ) проще электрически сканировать первичный пучок, нежели механически перемещать сам образец. Электронный луч в ЭЛТ синхронизирован с первичным ионным пучком, и усиленным сигналом вторично-ионного детектора модулируются интенсивностьэлектронного луча в ЭЛТ. Получаемое при таком методе увеличение изображения равно отношению длины строки на экране ЭЛТ к расстоянию на поверхности образца, пробегаемому первичным ионным пучком в процессе сканирования.
Все установки ВИМС позволяют осуществлять анализ поверхности и распределения концентрации элемента по глубине. Они различаются в таких важных отношениях, как порог чувствительности при детектировании, разрешение по массам, плотности тока первичного пучка, вакуумные условия в окрестности мишени, а такжевозможность проведения анализа распределения элементовпо поверхности, или топографического (x-y) анализа, путем сканирования зондом или формирования изображения. К устройствам для топографического анализа относят лишь те, которые позволяют получить разрешение по поверхности не хуже 10 мкм. Все существующие установки ВИМС можно разделить на три группы в соответствии с принципом их устройства и пригодностью для микроанализа:
·не позволяющие осуществлять анализ распределения элементов по поверхности;
·дающие сведения о распределении по поверхности с помощью сканирующего ионного зонда;
·дающие сведения о распределении по поверхности методом прямого изображения.
Установки, не обеспечивающие анализа распределения частиц по поверхности
Ряд вторично-ионных масс-спектрометров был сконструирован для решения частных аналитических проблем или исследования различных закономерностей вторичной ионной эмиссии.
Использованные на ранней стадии исследований этого явления анализаторы с однократной фокусировкой (секторные магниты) имели весьма ограниченное разрешение по массам и низкую чувствительность, что было обусловлено большим разбросом начальных энергий вторичных ионов.
Внастоящее времябольшое внимание уделяется квадрупольным анализаторам, посколькуони, будучи просты инедороги, позволяютполучать сведенияоповерхности и профиле концентрациипримесипочти во всех случаях,когда нетребуется информациио распределениипоповерхности илиоченьмалых количествах примеси. Добиться снижения фона при работесквадрупольным фильтроммассможно за счет предварительной селекциивторичных ионовплоскопараллельным электростатическим анализатором с малой диафрагмой, атакже внеаксиального расположения ионного детектора.
Установки, позволяющие получать сведения о распределении элемента по поверхности, со сканирующим ионным зондом
УстановкиВИМС, относящиеся к этой категории, обычно называют ионными зондами. В этих установках первичный пучок анализируетсяпо массам и может быть сфокусирован в пятно диаметром от 2 и менее до 300 мкм. Масс-спектрометр представляет собой устройство с двойной фокусировкой и хорошим пропусканием частиц, позволяющее давать стигматическое изображение при среднем разрешении по массам. Схема такого прибора приведена на фиг.7.

Фиг.7. Схема ионного микрозонда[4].
Установки с прямым изображением
Первой установкой ВИМС, которая позволила получить изображение объекта в лучах выделенных по m/е ионов и визуально наблюдать распределение элемента по поверхности, был масс-спектральный микроскоп, его схема представлена на фиг.8. Уникальная особенность масс-спектрального микроскопа - возможность наблюдать за интенсивностью вторичных ионов со специально выделенного микроучастка поверхности независимо от размеров и местоположения первичного пучка, пока хотя бы часть его попадает на интересующий нас участок поверхности. Эта возможность является ценной в некоторых случаях анализа методом ВИМС распределения элементов по поверхности и в объеме. Ниже будут рассмотрены некоторые из наиболее важных преимуществ, а также и недостатков, свойственных различным типам приборов.
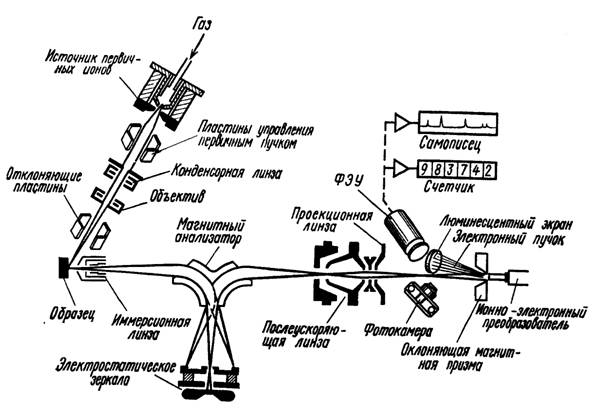
Фиг.8. Схема масс-спектрального ионного микроскопа[4].
Порог чувствительности
Минимально обнаружимый уровень содержания элемента в данной матрице зависит от свойств самого элемента, химического состава матрицы, в которой он присутствует, сорта первичных ионов, их тока, попадающего на образец, телесного углаотбора частициэффективности прохождениявторичных ионовчерез анализатор, его общего фона, а также фонаи эффективности детектора.Все перечисленныефакторы, кромедвух первых, определяютсяконструкциейприбора и, следовательно,могут бытьоптимизированыс цельюдостижения наиболее высокойчувствительности. Поскольку распыление являетсяразрушающим процессом, для минимизации количествапотребляемого материала необходимы высокоэффективные анализаторы ивысокая чувствительность.Ввидутого чторазличныеконструкции установокВИМС предназначенылибо длявыявлениятех илииныхотдельных особенностей,либодля обеспечениянаибольших удобствизмерений,они весьмасильно различаютсяпо чувствительности.Удобной мерой чувствительности может служитьотношениечисла регистрируемыхвторичных ионов кчислу первичных при некихстандартных условиях:образец, сорт первичных частиц и некоторое минимальное разрешение по массе. Установки ВИМС, позволяющие регистрировать »106ион/с характерногоэлементаиз оксиднойматрицы (например, ионы Fe+ изобразца Fe2O3)при токе первичного пучка10-9А, классифицируютсякак имеющие чувствительность, достаточную дляобнаруженияследов элементов идля микроанализа поверхности.
Химическийсостав матрицыобразца оказывает непосредственноевлияние напорог чувствительностидля тех или иныхэлементови являетсяосновным источником неконтролируемыхизменений этойвеличины.Матрица влияетна порог чувствительностидвояким образом:отнее зависиткоэффициент SA±из-за различий в электронных свойствах материалов, иона может давать нежелательные молекулярные и многозарядные ионы, которые окажутся в масс-спектрев диапазонемасс, интересующем исследователя. Ночисло молекулярныхионов быстроуменьшаетсяс ростомчисла атомов, входящих в состав молекулы, и вбольшинстве случаевпри концентрацияхэлемента, непревышающих10-4, особыхсложностей в связи с наложениями пиков не возникает.

Фиг.9. Участок масс-спектра вторичных ионов
флюорапатита вблизи массы 43 при разном разрешении по массам: а-300; б-1000; в-3000[1].
Перекрытие пиков от атомарныхи молекулярныхионов можновыявить двумя способами:путем анализабыстрых вторичных ионовили применением анализаторовпоm/есразрешением М/DМ> 3000. Впервом случае коэффициентионнойэмиссии уменьшаетсяпримерно во столькожераз, восколько коэффициентвыбивания молекулярныхионов уменьшаетсяпо сравнениюс атомарными. В некоторыхслучаях этотметод вполне приемлем; нопри решении
многочисленных задачобнаруженияследов примесейили микроанализаповерхности недопустимобольшоеснижение чувствительности характерное для этого метода. Второй способ является более прямым и с точки зрения анализа более предпочтителен. Чтобы выявить сложную структуру отдельных пиков в масс-спектрахиспользуют для ВИМС приборы с высоким разрешением по массе. На фиг.9,представлена форма пика с массой 43 ат. ед. при разных разрешениях анализатора. Высокое разрешение очень важно для уменьшения или исключения в идентификации пиков m/е, особенно если основной целью является обнаружение следов элементов на уровне атомных концентраций, не превышающих 10-5.
Вопрос о пороге чувствительности метода ВИМС для различных элементов исследовался многими авторамикак теоретически, так и на основе результатов экспериментальных измерений. При этом были получены следующие примерные значения, подтвердившиеся в некоторых строго определенных условиях: менее 10-7 моноатомного слоя, атомная концентрация 10-9 и менее 10-18 г элемента. Но эти значения характерны лишь для некоторых частных случаев и не являются нормой на практике. Обычно мы имеем дело со сложными спектрами с многократными наложениями линий, в силу чего порог чувствительности оказывается сильно зависящим от природы матрицы образца. Поэтому, указывая порог чувствительности, необходимо указывать и соответствующие дополнительные факторы, в частности тип матрицы, и не следует делать огульные утверждения относительно того или иного элемента.
Если пренебречь возможным перекрытием пиков, то порог чувствительности для некоторого элемента в матрице обратно пропорционален току первичных ионов IP, попадающему на образец. На фиг.5и 10 показано, как
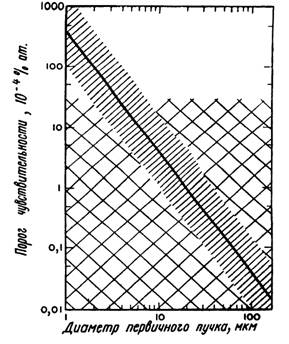 Фиг.10.
Зависимость порога чувствительности типичного
прибора ВИМС от диаметра первичного
ионного пучка[1].
Фиг.10.
Зависимость порога чувствительности типичного
прибора ВИМС от диаметра первичного
ионного пучка[1].
изменяется порог чувствительности в зависимости от различных параметров, влияющих на ток первичных ионов. Приведенные здесь значения порога чувствительности основаны на экспериментальных данных, полученных в типичных для анализа условиях, когда первичными частицами служат ионы О2+. Область с простой штриховкой на фиг.10 вблизи линии 5 мА/см2 соответствует диапазону плотностей токов первичных частиц, обычно применяемых в установках типа ионного микрозонда или масс-спектрального микроскопа. Область с двойной штриховкой отвечает условиям, при которых существенно наложение линий сложных молекулярных ионов, и необходимо позаботиться об идентификации пиков по m/е. Истинное положение или высота этой области зависит как от матрицы образца, так и от разрешения по массам и чувствительности масс-анализатора. Для
микроанализа поверхности, т.е. исследования областей диаметром <3 мкм, методами ионного зонда или масс-спектрального микроскопа минимально детектируемый уровень сигнала выше уровня, при котором становится важным перекрывание пиков молекулярных ионов (фиг. 10); следовательно, если требуется осуществить только общий анализ малых участковтвердого тела, товысокое разрешениепо массам не обязательно.Если жеинтересоватьсяследами элементов всложных матрицах,то необходимоиметь масс-анализатор свысоким разрешениемпо массам.
Анализ следов элементов
Предполагаемый порог чувствительности метода ВИМС для многихэлементовблизок к10-9.Но для обеспечения общегопорогачувствительноститакого порядканапрактике необходимо использовать (как видно из сказанного выше) масс-апализаторысвысоким разрешениемивысокой чувствительностьюкотносительномусодержанию и, крометого, контролировать ряд эффектов, о которых говорится ниже.
Большаячасть вторичныхионоввыходит из нескольких наружныхатомныхслоев твердоготела,а поэтомувещество,адсорбированное наповерхности, выступаетв спектре как важныйкомпоненттвердого телаилиего поверхности.Среда,окружающая образец, обычносодержит молекулыуглеводородов, Н2, N2, О2,Н2О, СО2и СО.Поэтому обнаружениев матрице следовтакихэлементов, какС, N, Н иО, оказываетсявесьма сложнымвтом случае,еслине приняты специальныемерыдля сведениякминимуму их влияния. Мерыэти таковы:проведение измеренийвсверхвысоком вакууме,свободномот углеводородов,применение криогенной и геттернойоткачки объемавблизиобразца и работапри высокихплотностях тока первичных ионов, при которых скорость удаления поверхностных слоев в результате распыления намного больше скорости поступления частиц загрязнений. При давлении 10-8 мм рт. ст. скорость прихода на мишень атомов или молекул остаточных газов приблизительно равна скорости поступления ионов первичного пучка с плотностью тока - 10 мА/см2.
Источниками загрязнений служат также поверхности , расположенные вблизи мишени, на которые попадает значительное количество распыленного вещества. Часть этого вещества врезультате испарения или распыленная вторичными и отраженными ионами может возвращаться на мишень. Это так называемый “эффект памяти”, и его значение в конкретном анализе зависит от предыстории образца. Данный эффект наиболее значителен в приборах, где используются большие токи первичных ионов, а вытягивающие линзы расположены вблизи поверхности изучаемого образца.
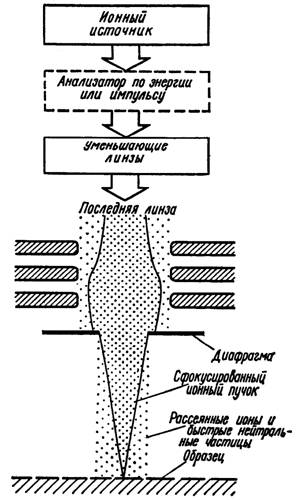
Фиг.11. Компоненты сфокусированного ионного пучка, связанные с рассеянными ионами и нейтральными атомами[1].
Чтобы предупредить внедрение в образец того элемента, содержание которого определяется, особенно важна химическая чистота первичного ионного пучка. При типичных условиях (скорость распыления образца, пробел и разброс по пробегам первичных ионов) и в предположении, что распыление продолжается достаточно, долго, для того чтобы воздействовать на уже легированную зону, а основным источником ионов примеси является обратное распыление ранее внедренных частиц, присутствие в первичном ионном пучке 10-6 загрязнений должно проявиться как объемная примесь с атомной концентрацией ~10-7. Чтобы гарантировать чистоту первичного ионного пучка и исключить возможность осложнений на уровне следов элементов, желательно осуществлять сепарацию пучка первичных ионов по массе.
Чтобы уменьшить влияние загрязнения поверхности остаточными газами, при анализе объемного состава твердого тела обычно пользуются первичными ионными пучками с высокой плотностью тока. При этом область
малой плотности тока, т.е. периферийная часть пучка, дает основной вклад во вторично-ионный сигнал того элемента, который присутствует одновременнокакв остаточном газе, так и в твердом теле в виде микропримеси.К подобному эффекту может привести не только загрязнение атомами остаточных газов (обычно наиболее существенное), но и любые иные источники поверхностных загрязнений, действующие во время измерений. Для установок ВИМС, основанных на обычной методике масс-спектрометрии, указанная проблема более важна, чем для масс-спектральных микроскопов. В последнем случае можно в плоскости изображения поместить вырезающую диафрагму так, чтобы отбирать лишь ионы, выходящие из средней, эффективно распыляемой части мишени, где равновесная поверхностная концентрация адсорбированных загрязнений минимальна.
Другой эффект, в известной мере аналогичный рассмотренному выше эффекту периферийной области пучка, поясняется схемой, представленной на фиг.11. Он связан с облучением большой площади образца быстрыми нейтральными атомами,образующимися в результате перезарядке при столкновениях первичных ионов с атомами, а также рассеянными ионами, возникающими при фокусировке первичного ионного пучка на мишень. Размер облучаемой этими частицами области определяется ограничивающими диафрагмами на пути ионного пучка и обычно превышает 250 мкм. Роль этого эффекта зависит от давления остаточных газов, конструкции линз, расположения иразмеров диафрагм и геометрического устройства электродов колонны. Такая несфокусированная часть облучающего мишень потока непосредственно не зависит от сфокусированного ионного тока, поступающего на образец, но в основной своей части определяется полным потоком ионов в колонне.
В микрозондовом варианте метода ВИМС эти эффекты гораздо более серьезны, нежели в масс-спектральных микроскопах. Но к существенным ошибкам при анализе с применением микрозонда они приводят только в том случае, когда большая площадь, облучаемая несфокусированной частью пучка, замет но отличается по составу от анализируемой точки. При диаметрепучка, равном нескольким микрометрам, несфокусированный компонент может облучать большую площадь поверхности образца и составлятьболее 1% ионного потока.Особенно неблагоприятные условия возникают, если детали колонны формирования первичного пучка (ионный источник, линзы, отражатель, диафрагмы)размещены наоднойоси, пересекающейсяс осью анализаторавторичныхчастиц. Этотэффект можно сильноослабить, если отклонить первичный пучок от оси прибора и диафрагмировать его вблизи самого образца.
Другойметод, пригодныйприобъемном анализе вусловиях, когдаповерхность образцанеоднородна по составуили загрязненаэлементами, присутствие которых вобъеме и исследуется, заключаетсяв нанесениина поверхностьпленки слоя высокочистого углерода(или другого элемента,отсутствующего вобъеме и не представляющего интереса в проводимою анализе) толщиной200 - 500 А.В анализируемойточке этот слой можетбыть легкоудален первичнымпучком большой плотности.В тоже время “хвост” малойплотности токана краях пучка инесфокусированные компоненты первичного пучка будут попадать на поверхностьиз чистогоуглерода, и, следовательно,области поверхности,отличные от центральной, не дадут какого-либо вклада в сигнал.
Ионное изображение
Вторично-ионное изображение, дающее двумернуюкартину размещения элементапо поверхности,может бытьполучено либо методом масс-спектрального микроскопа, либо методом сканирующего микрозонда. В масс-спектральных микроскопах разрешение по поверхности не зависит от размеров первичного ионного пучка; оно определяется аберрациями оптики анализатора вторичных ионов и хроматическими аберрациями, обусловленными разбросом вторичных ионов по энергиям. Если улучшать разрешение введением фильтра энергий, тоснижается “светосила”прибора (число регистрируемых вторичных ионов, приходящихся на одну первичную частицу). В масс-спектралъных микроскопах достигнуто поверхностное разрешение ~1 мкм.
В приборах со сканирующим микрозондом поверхностное разрешение ограничено диаметром первичного пучка, а потомуопределяется качеством системы, фокусирующей первичный пучок. При высокой степени фокусировки (пучки диаметром менее 1мкм) значительныйвклад в полный потокпервичных частиц,падающихна образец,можетсоставить несфокусированныйкомпонент и,следовательно, должны бытьприняты мерыдля его устранения. Светосилаприбора такоготипаостается постояннойпри любомповерхностном разрешении,так каконаопределяется анализаторомвторичныхионов, а не размерами первичногопучка. Вмикрозондовых приборах было достигнуто разрешение 1 - 2 мкм. Предельное разрешение,которое можнонадеяться получитьв приборах свторичнойионной эмиссией,-порядка 100А.Это ожидаемое значение -физический предел,обусловленный характеристиками каскадовстолкновений, перемешиваниемв приповерхностных слоях, вызываемым первичнымиионами, исредней глубиной выхода вторичных ионов. Однако практически из-за ограниченной выходной интенсивности источника первичных ионов и недостаточно высокого качества оптики электростатических линз нижний предел размеров ионного пучка оказывается~ 1000 А.
При одинаковом поверхностном разрешении и при одинаковых плотностях первичного тока масс-спектральный микроскоп требует для получения ионного изображения большой площади (например, 200 Х 200 мкм2) меньше времени, чем сканирующий микрозонд. Дело в том, что в микроскопе информация собирается одновременно от всех точек поверхности, а не последовательно от точки к точке. Но если интересоваться малыми участками (20 Х 20 мкм2), то время формирования изображения, получаемого при помощи микрозонда, оказывается таким же, как и в масс-спектральном микроскопе, или даже меньшим. Это объясняется большим усилением в регистрирующей системе микрозондовых устройств (электронный умножитель и ЭЛТ с модуляцией яркости) и сравнительно низкой чувствительностью фотоэмульсий, применяемых для регистрации изображений.
При анализе малых площадей сканирующий микрозонд дает еще два преимущества: меньше участок поверхности, испытывающий возмущение, а изображение, получаемое на экране ЭЛТ, сразу же пригодно для анализа.
Требования к первичному ионному пучку
Первичный ионный пучок играет очень важную роль в приборах ВИМС; поэтому целесообразно остановиться на некоторых желаемых характеристиках пучка и системы его формирования, о которых ранее не говорилось. Эта система должна создавать сфокусированный и стабильный пучок ионов инертного газа (например, Аг+), а также положительных и отрицательных ионов химически активного газа (например, О2+ и О-). Ионы активных газов нужны при объемном анализе твердого тела, а при облучении отрицательными ионами снижается роль зарядки поверхности.
Накопление заряда на поверхности зависит от рода первичных ионов, их заряда, энергии и плотности тока, размеров облучаемой области, а также проводимости и толщины слоя диэлектрика. Локальные изменения потенциала поверхности могут вызывать ряд нежелательных эффектов: смещение пучка, миграцию элементов в имплантированной зоне, а также изменение энергии вторичных ионов и уменьшение эффективности их собирания вследствие искажения вытягивающего ионы поля в непосредственной близости от поверхности образца. Расчет влияния зарядки поверхности на траектории вторичных ионов, выбиваемых из диэлектриков.
В ВИМС существует несколько способов уменьшения образования положительного заряда на поверхности: облучение ее широким потоком электронов, которые эмитируются расположенным неподалеку термокатодом, облучение пучками отрицательных ионов, повышение давления кислорода вблизи образца до 10-4 мм рт. ст. При исследовании объема диэлектриков (в отличие от тонких диэлектрических пленок на проводнике) для эффективного отбора вторичных ионов в анализатор необходимо создать между образцом и электродом, вытягивающим вторичные ионы, надлежащий градиент электрического поля. С этой целью на поверхность диэлектрика наносят проводящую пленку или накладывают металлическую сетку.
Газоразрядные источники, используемые обычно для получения первичных ионов, сильно повышают давление газов в объеме прибора; поэтому крайне желательно предусмотреть дифференциальную откачку системы формирования пучка. Сепарация первичных ионов по массам важна дляочистки пучка, но не только от инородных элементов, а и отмолекулярных частиц, что необходимодля определенияхарактеристик каскадов столкновений и их влиянияна разрешениепо глубине и перемешиваниеатомовв приповерхностномслое. Кроме того,система формированияпервичного пучкадолжна позволять развертывать его врастр для однородного распределения первичного потока по поверхности, что необходимопри изучениипрофилей концентрациипримеси.Наконец, прианализе микрообластейжелательно иметьвозможностьвизуально наблюдатьза поверхностьюобразцавблизи местапопадания ионного пучкапосредством высококачественнойоптической системы с большим увеличением.
Масс-спектрометрический анализ нейтральных распыленных частиц
При распылении большинства материалов доля частиц, выходящихиз мишениввиде нейтральныхатомов, значительно выше, чем выходящих в видеионов. Поэтомуестественным развитием и дополнением ВИМС является метод ионизации и последующего анализа выбитых нейтральных частиц. Такой метод получил название масс-спектрометрии ионизованных нейтральных атомов. Одним из его преимуществ является то, что нейтральные частицы можно ионизовать за счет такого процесса, который, не зависит ни от матрицы, ни от свойств поверхности образца. Основные же недостатки масс-спектрометрии ионизованных нейтральных атомов - то, что ионизуются все частицы, присутствующие в газовой среде прибора, а эффективностьотбора ионизованныхчастиц ванализатор значительно меньше, чем в ВИМС. Если доля ионов среди выбитых вторичных частиц gA±превышает 10-4(что выполняетсядля большинстваэлементов иматриц), томасс-спектрометрия ионизованныхнейтральных атомовнеможет конкурироватьсВИМС по абсолютнойчувствительности SA±.
Нейтральныечастицы, выбитыеизмишени газовымиионамииз разряда, ионизуются вследза темэлектронным ударом; путем перезарядки или за счет пеннинговского процесса газоразрядной плазме. Чувствительность методаи целесообразность егоприменениязависят отэффективностиотбора образовавшихся ионов и от того, оптимизованыли условияразряда так, чтобывероятностьионизации анализируемыхнейтральныхчастиц была больше вероятности ионизации всех других частиц газового разряда.
Исследование распыления и ионизации нейтральных атомов в высокочастотном разряде в инертных газах показало, что такой метод имеет практическую ценность. Разброс по энергиям, ионов, отбираемых из источника с высокочастотным тлеющим разрядом, не превышает 1 эВ, и для их разделения по массам эффективно использовать квадрупольный анализатор без предварительного фильтра энергий. Установлено, что нейтральные атомы ионизуются в основном за счет пеннинговского механизма. Эффективность ионизации нейтральных частиц в этом случае лишь слабо зависит от природы частиц и совсем не зависит (в противоположность методу ВИМС) от типа матрицы и условий на поверхности образца. Следовательно, относительные ионные сигналы с достаточно хорошим приближением равны относительным концентрациям соответствующих элементов в матрице. При использовании образцовс большойповерхностью( ~10см2) вэтом приборе удалось регистрировать атомные концентрации элементов на уровне10-6.Типичные значенияскоростей распыления лежат в интервале от 10-2 до 10 моноатомных слоевв секунду, причем с равным успехом могут анализироваться как проводники, таки диэлектрики.Таким образом,не давая сведений о распределении веществапоповерхности, методмасс-спектрометриитлеющего разрядапозволяет определятьхимический состав поверхности иобъема, а также даетвозможность измерять распределениеэлементапо глубине.Метод имеетряд привлекательныхособенностей, которыеделают целесообразнымего дальнейшее развитие.
Количественный анализ
Коэффициентвторичной ионнойэмиссии SA±зависит от целого ряда факторов, таких, как состояниеповерхности образца, природаегоматрицы, иразличных эффектов,вызываемых первичным пучком.Следовательно, сопоставление интенсивностейвторичных ионовданного элемента из различныхточек поверхностиобразца не всегда непосредственно отражаетраспределениеэтого элемента поповерхности. Приоценке такого рода данныхи особеннопри интерпретации ионного изображения поверхности необходимо соблюдать осторожность.
Эти изменения вызваны эффектами, зависящими от химической природы и кристаллической структуры материала, а также от относительной ориентации зерен на поверхности. К таким эффектам относятся каналирование первичных ионов, индуцированнаяоблучением рекристаллизация, различия в концентрации внедренного кислорода и различия в угловом распределении вторичных ионов, выбитых из по-разному ориентированных зерен сплава. Относительные изменения интенсивности ионов при переходе от одного зерна к другому приблизительно одинаковы для всех элементов. Если измеряемые интенсивности в каждой точке отнести к интенсивности ионов основного элемента, то разница между зернами сглаживается или совсем исчезает. Наблюдения такого родапоказывают,что любые количественные оценкиследует основывать ненаабсолютных значенияхкоэффициента SA±, ана относительных значениях выхода различныхионов изанализируемой точки.
Точностьи воспроизводимость результатов измерений относительных коэффициентовионнойэмиссии вВИМСоказывается весьма удовлетворительной(в контролируемыхусловиях (5%).Если необходимаяточностьне обеспечивается,то нет смысла и говорить о количественноманализе. Принимая во внимание сложность явления вторичной ионной эмиссии и существенные различия приборов ВИМС, трудно создать чисто теоретическую модель, пригодную для любых установок, образцов и условий анализа. Например, приборы ВИМС не собирают все вторичные ионы и не обеспечивают прохождения через анализатор всегда одной и той же доли ионов. Это связано с зависимостью пропускания анализатора от начальной энергии частиц. Оказывается слишком много переменных для того, чтобы можно было правильно рассчитать все чисто теоретически. Поэтому любой метод количественных оценок должен содержать минимум переменных параметров и быть пригодным для каждого прибора ВИМС. Такой метод обязательно будет эмпирическим или полуэмпирическим по своему характеру и потребует эталонов для определения чувствительности к тому или иному элементу.
Чтобы успешно проводить количественный анализ методом, основанным на градуировке по эталону (да и вообще любым методом), важно стандартизировать рабочие параметры прибора: сорт первичных ионов, их ток, плотность тока и энергию, окружение образца, эффективность детектирования и энергетическую полосу пропускания анализатора вторичных ионов. Только тогда, когда эти условия фиксированы, приобретают какой-то смысл результаты анализа с использованием коэффициентов относительной чувствительности к элементам, полученныхдля эталоновблизкогок образцусостава.Если скомбинироватьравенства(1) и (2)и поделитьрезультат на такое жесоотношение для эталонного элемента,чтобы исключитьконстанты, то мы получим
 (4)
(4)
гдеiA± и iA± -сигналы вторичныхионов, а СA иСэт- атомные концентрации элемента А и эталонногоэлемента вматрице. Пользуясь коэффициентами относительной чувствительности jА, найденнымитаким образом,можно по измеренным ионнымсигналам для анализируемого образца вычислить относительную атомнуюконцентрацию элементавнем:(iA± /iA±) jА = СA /Сэт.Все относительные атомные концентрации можно нормировать к100%,и тогдамыполучим составматрицыв атомныхпроцентах при условии, что порог чувствительностиустановки ВИМСдостаточендля регистрациивсехосновных компонентов образца.Метод,описанный выше,в различныхвариантах применялсядля объемногоанализаразличных матриц.Вобщем точностьтакого количественногоанализа должнасоставлять 10%. Но притаком методепредъявляются весьма жесткиетребованияк эталонамик однородности исследуемого образца. Точностьподобныхизмерений, естественно,не выше, чем точность эталона или однородность образца.
Создатьэталоны длялюбыхматриц, какие толькомогут встретиться, невозможно. Поэтому необходимыэмпирические способы,которые позволяли быпо даннымдля нескольких эталонных образцов определять коэффициентычувствительности jА длялюбой матрицы.Величина jА будет зависетьот параметра eS характеризующего электронные свойстваэмитирующейионыповерхности.Общий характерзависимостиjА(eS)показан на фиг. 12. Простейшийспособоценки eS, состоит в нахождении eS = k(j1/j2), где k- произвольная постоянная, а j1 и j2 - коэффициенты относительнойчувствительностидля элементов 1и 2,так что отношение j1 к j2 зависит от матрицы.Информацию обeS содержащуюсявспектрахвторичных ионов,дают такжеотношения вторичныхионов М2+/М+, МО+/М+,МN+/М+. Стандартизировавусловия функционированияустановки исобравэкспериментальныеданные типапоказанных нафиг. 12 для эталонныхобразцов, уже можноизвлекатьиз сигналов вторичных ионовдостаточно точную количественную информацию почти при любой матрице (если только для нее известна величина eS).ъ
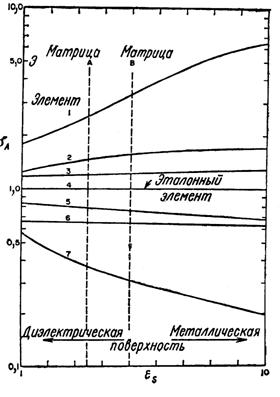
Фиг.12. Зависимость коэффициентов jАотносительной чувствительности к разным элементам от типа поверхности образца[1].
При определении величины eS, следует отдавать предпочтение тем способам, которые основаны исключительно на информации, содержащейся в спектрах вторичных ионов или отношениях величин пиков этих ионов в спектре для неизвестного образца, т.е. информации типа отношений интенсивностей ионов М2+/М+, МО+/М+, МN+/М+ (иди любых других), зависящих от eS,но не зависящих от концентрации элементов. Кроме того, величину eS, можно рассчитать исходя из отношений ионных сигналов и концентраций двух или более компонентов, для которыхjА/jА’ зависит от матрицы. Подобный метод пригоден при обнаружении следов элементов в хорошо известной матрице. И наконец, можно просто выбрать величину eSруководствуясь исключительно аналитическим опытом и интуицией. Такой способ не так уж плох, как могло бы показаться. По крайней мере исключаются грубые ошибки (фиг. 12).
Единственный набор коэффициентов чувствительности позволяет определять концентрации с ошибкой не более чем в 2 разадля большинстваэлементов вряде весьма различающихся матриц.Любая модель,котораявводит вкоэффициентыотносительной чувствительностипоправкуна влияниематрицы,может лишь улучшить результаты. Привлекательные стороныописанного вышеподхода таковы: простая модель,которую можноиспользоватьв любомприборенезависимо откаких- либотеоретических илифизическихконстант и которая основываетсяисключительнона эталонахиизмерениях вданном приборе.
Вышеосновной упормыделали на анализобъемного составатвердых тел,а нетонких поверхностныхслоев. Поскольку объемныйсостав твердых мишенейможно задатьдостаточно точно,они ислужатэталонами дляпроверки количественныхмоделей. Дляповерхностныхпленок толщинойменее 50 А эталонылибовообще невозможно,либо оченьтрудно изготовить.
Следовательно, количественныеданныедля внешних 50А можнополучить лишь так же,как ив случае объемного образца, когда нет эталона.
Глубинные профили концентрацииэлементов
Приисследовании распределениятого или иного элементапослоям, параллельнымповерхности образца,для обнажения глубоколежащих слоев твердого тела in situв большинстве методов анализа поверхности (нетолько ВИМС)применяют распыление ионами.При этом разрешение поглубине, обеспечиваемоевыбраннымметодом анализаповерхности, оказывается не очень существенным,поскольку разрешениебудет определятьсяв основном перемешиванием вприповерхностных слоях идругимипроцессами, сопровождающими травлениеповерхности.
Разрешениепо глубине, обеспечиваемое приданном методе определенияпрофилейконцентрации, можно характеризовать тем уширением профиля тонкогоповерхностного слояили резкойграницы разделамеждудвумя различнымиматериалами, котороеобусловлено самимпроцессом измерения.Если толщина слоя(или глубиназалегания границыраздела) превышает примерно2RP тоиз-за различныхфакторов,вызывающих уширениеизмеряемого профиляконцентрации (приборныхи ионно-матричных эффектов), распределениедля тонкогослоя оказываетсяблизким кнормальному распределениюсо среднеквадратичнымотклонением sR.За разрешениепоглубине можно принять величину sR для этогораспределения. Еслислой толстый, тосреднеквадратичное отклонениеsМ экспериментально наблюдаемого (измеренного) профиля связано сsR и sТ соотношениемs2М =s2R+s2Т , гдеsТ -среднеквадратичное отклонение истинного распределения слоя. При sМ >>sТ , например в случае тонкого слоя, величина sR приблизительно равна разрешению sR метода по глубине.
Еслипринять, что измеренныйпрофиль тонкогослоя описываетсянормальным распределением,томожно рассмотреть ислучай уширения границыраздела, иего связь с разрешениемпо глубине. Эторазрешение можновычислить по профилю ступенчатого измененияконцентрации(ширина ступени>> sR),когда форма истинногокрая ступени похожа накривую интегральногонормального распределения сосреднеквадратичнымотклонением st.Если концентрацияизменяется резко(st~0),то разрешению по глубине sR соответствует величинаsm, половинарасстояния междуглубинами,отвечающими 84 и16% измеренной на опытевысоты ступени.В случаеграничной области со значительнойсобственной шириной (т. е. со значительным st) разрешение по глубина дается формулой sR =(s2m -s2t)1/2,причем нужно учитывать ошибкив величинахsm и st. Случай профиля слоя ссущественным sT можно рассчитать аналогично.
Всесказанное вданномразделе касаетсясамых основныхфизических илиприборныхэффектов, связанныхс травлением поверхности ионнымпучком ипроблемой распыления ионамибезискажения профиляконцентрации.Поэтому многоеиз сказанногоотносится клюбомуиз методованализаповерхности с использованием ионного травления.
Измерениепрофилей методом ВИМСсводится крегистрациисигнала вторичныхионовинтересующего насэлемента какфункции временираспыления. В случае однороднойматрицы этовремя,выполнив соответствующие градуировочныеизмерения(распыление пленкиизвестнойтолщины, измеренияглубиныкратера, коэффициентовраспыленияи т.д.),можнопересчитать вглубинузалегания элемента.Изменение интенсивностивторичных ионов невсегда отражаетотносительное изменение концентрации элемента; поэтому нужна осторожность при интерпретации глубинныхпрофилей, особенно вблизисамой поверхности,т. е. когда глубина меньше RP+2DRP,а также пленок, состоящихизразличающихся посоставу слоев,или матриц с неоднородным распределениемследовэлементов, которыеспособныдаже прималойконцентрации сильно повлиятьна вторично-эмиссионные свойства образца. Впоследнем случаедляполучения результатов, отражающихреальную ситуацию,следуетобработать измеренныепрофилитак, как этоделается при количественной интерпретации интенсивности вторичных ионов.Если этоневозможно, нужнопопытаться по крайнеймерепроградуироватьинтенсивность вторичных ионов изучаемого элемента по одному или нескольким элементам, равномерно распределенным в пленке. В общем абсолютная интенсивность вторичных ионов дает прямую информацию о
распределении элемента по глубине лишь при малых концентрациях примеси в аморфной или монокристаллической матрице с равномерно распределенными основными компонентами и лишь при глубинах под поверхностью, превышающих 50 А.
Пригодность метода ВИМС для определения глубинного профиля наряду с его высокой чувствительностью к большинству элементов делает его весьма привлекательным как метод изучения тонких пленок, ионной имплантации и диффузии. Факторы, существенные при проведении глубинного анализа методом ВИМС,могут быть разделены на две группы: приборные и обусловленные особенностями сочетания ион - матрица.
Приборные факторы, влияющие на разрешениепо глубине при измерении профилей концентрации
Получитьпри методеВИМСнадежные сведенияо глубинномпрофиле можнолишь втом случае, если поддерживаетсяпостоянная интенсивность тока первичных ионов и обеспечивается однородность плотности тока пучка в той части поверхности, из которой вмасс-анализатор отбираютсявторичные частицы. В стационарном сфокусированном ионном пучке плотность тока, падающего на образец, не постоянна по сечению пучка, а следовательно, и распыление поверхности в этих условиях не может быть равномерным. Если зона, из которой поступает информация, охватывает все сечение первичного пучка, то вклад в сигнал ионов с краев кратера будет искажать профиль концентрации элемента в приповерхностном слое (фиг. 13).
Ошибки такого рода устраняются в ВИМС разными способами в зависимости от конструкции прибора. В устройствах, в которых не предусмотрена возможность определять распределение элемента по поверхности, обычно расфокусируют пучок так,чтобы егосечение было больше анализируемой области или вырезаютпри помощи диафрагмы из расфокусированного пучка определенный участок с однородной плотностью тока. Иногда на поверхности мишени помещают тонкую маску из
материала, не дающего вторичных ионов, близких к анализируемым,которая ограничивает вторичнуюионную эмиссию из областей неоднородной плотности первичного пучка.
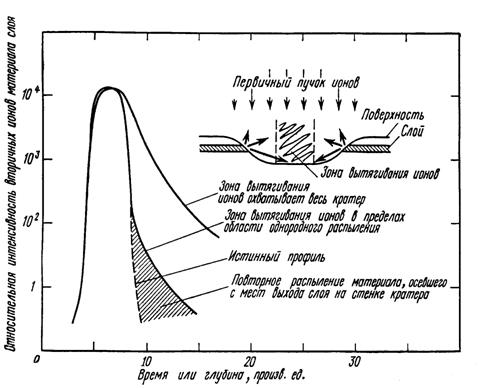
Фиг.13. Переменный профиль концентрации в приповерхностном слое с указанием различных приборных факторов, которые приводят к искажению профиля по
сравнению с истинным распределением[1].
Наиболее удовлетворительный способ решения проблемы - электрически развертывать сфокусированный ионный пучок в растр по достаточно большой площади поверхности мишени так, чтобы обеспечить в ее нейтральной части однородную плотность тока. При этом нужно уделить особое внимание системе развертки пучка: напряжение строчной и кадровой развертки должно изменяться линейно со временем, обратный ход пучка должен бланкироватьсяили хаотизироваться, а скорость развертки должна быть согласована с размерами пучка, чтобы соседние строки растра перекрывались.
Чтобы полностью использовать достоинства этого метода, необходимо ограничить зону отбора вторичных ионов областью однородной плотности пучка. Осуществить это сравнительно просто в установках ВИМС, которые позволяют получать сведения о распределении вещества по поверхности. Всканирующей микрозондовой установке,где первичныйионный пучокмалого диаметра разворачивается в растр по поверхности,можно работатьв режиме, в которомсистема детектированиярегистрирует вторичныеионы лишьприпрохождении лучомвыделенного “окна”.
Даже тогда, когда зона, из которойсобирается информация, ограниченаобластьюоднородной плотности тока,имеется еще ряд приборныхэффектов, приводящихк искажению формы профилей концентрации. К примеру, эффектобратного осаждения на мишеньранеераспыленного вещества:материал, распыленный с краев кратера, оседает на его дне (в том числе на поверхности анализируемой зоны) и затемвновь распыляется(фиг. 13). Такойэффект обычно существененлишь приизмерении “хвостов” профилейс малойконцентрациейи сильно ослабляется, еслиувеличить крутизнустенок кратера.К аналогичным искажениямпрофилей концентрацииприводятадсорбция остаточных газов,или эффектыпамяти установки. Добавим, что любой фактор,влияющий наанализ следовэлементов методом ВИМС (наложение пиков молекулярных ионов, химическая чистота первичногоионного пучка,влияниенесфокусированного компонентаи периферийных частейпучка), такжеможет исказить профиль в области малых концентраций.
Влияние ионно-матричных эффектовна разрешение по глубине при измерении профилей концентрации
Ряд эффектов, вызывающих ошибки при измерении профилей концентрации, связан с характеристиками каскада столкновений, создаваемого в твердом теле первичным ионом. Два таких эффекта - влияние средней глубины выхода вторичных ионов и перемешивание атомов в поверхностном слое. В большинстве случаев распределение анализируемых частиц простирается на глубину свыше 100 А. В этих условиях атомные перемещения в приповерхностном слое, внедрение атомов отдачи и иные связанные с матрицей эффекты вносят в искажение профилей концентрации значительно больший вклад, чем глубина выхода вторичных частиц.
Основными параметрами, определяющими относительныепробеги частицв даннойпленке, являютсяэнергия первичныхионов, атомныйномерZ и масса А бомбардирующихчастиц иатомов мишени. Такимобразом, измеряемыйпрофиль концентрации должен зависеть от Z иА первичныхионов так же, какот их энергии.Еще один параметр, влияющийна егоформу, - угол падения, т. е. угол между первичнымионным пучкоми поверхностью мишени(обычно этот угол отсчитываютот нормалик поверхности).Увеличениеугла падения приводитк уменьшениюсредней глубины проникновения частицотносительно поверхностиобразцаи, следовательно,эквивалентно уменьшению энергии первичных ионов.
Крометого, уширениеилиуменьшение крутизны, профиля концентрацииможетпроисходить из-за диффузииэлементов, вызываемой или усиливаемой радиационными повреждениямив твердом теле, локальнымповышением температурыв облучаемойобласти исильнымэлектрическим полем,возникающим врезультате зарядкиповерхностипервичным пучком.Вобщем случае рольвсехэтик факторов предсказать трудно.Что же касаетсянапряженностиполя, товпленке толщиной1000 А при зарядке поверхности до 10 В она может достигать106 В/см.
Однойоднородности плотностипервичного ионноготока по поверхностинедостаточно длятого, чтобытравление образца протекалоравномерно. Скорость травленияопределяется топографиейповерхности,чистотой и однородностьюобразца, что в свою очередь зависит отего состава,физического состояния икристаллографическойориентации. Как правило,при контролируемыхусловиях работыустановки исостоянияобразца уширениепрофиля, связанноес процессом ионного травления,не превышает10% исследуемой глубины.
Внедренные первичные ионы и вызванные ими повреждения решетки мишени могут повлиять на форму профиля концентрации, оказав влияние на коэффициент распыления и вероятность ионизации распыленных частиц. Но если ионное травление осуществляется частицами с энергией 100 эВ/ат. ед. массы, то изменения матрицы вследствие внедрения ионов ограничены поверхностным слоем толщиной 100 А. За его пределами концентрация внедренных ионов остается постоянной и сохраняется стабильное состояние матрицы.
Применения
Приложения ВИМС можно разбить на пять широких (частично перекрывающихся) областей: исследование поверхности, глубинные профили концентрации, распределение по поверхности, микроанализ и анализ объема твердого тела.
Исследование поверхности
Вобласти анализаповерхностиВИМС применяется восновном дляидентификацииповерхностных атомов и молекулидляизучения динамикиповерхностныхявлений. Кроме того,динамику поверхностныхпроцессовможно изучать,невнося заметныхвозмущений, поскольку для полногоанализа достаточноудалить всего лишь 10-6 внешнего атомного слоя вещества. Методом ВИМСисследуются такиеповерхностные явления, каккатализ,коррозия, адсорбцияидиффузия.
Вприборах ВИМС,вкоторых предусмотрено всенеобходимое длянапускагаза инагреванияобразцов, можноизучать поверхностныепроцессы in situ.Информация, содержащаяся в масс-спектрах положительных и отрицательных вторичных ионов,даетнекоторое представлениео характере поверхностной связи и механизмах взаимодействия междугазом иповерхностью. К хорошо документированнымприменениям ВИМСпри изучении катализаотносятся исследованияразложенияи синтезааммиака нажелезе исостава поверхностногослоя серебра,используемогов качествекатализатора приокислении этилена.Каталитические процессы отличаютсяотреакций окисленияиликоррозии металловтем,что активная зонакаталитическихреакций поразмерам - порядка моноатомногослоя,тогда какприокислении она увеличивается из-за действияхимических смещающих сил, направленныхперпендикулярно границе раздела между адсорбированным слоем и металлом.Предметом ряда исследований, проведенныхметодику ВИМС,былиначальные фазыгазовойкоррозии иобразованияповерхностных соединений.
Извлечение количественной информации о поверхностном слое или зоне реакции на поверхности сопряжено с известными трудностями. Но как показано выше, процессы на поверхности часто можно изучать и без приведения полученных данных к атомным концентрациям частиц. Тип вторичных ионов и изменение их токов в зависимости от времени, температуры и давления газа дают достаточную информацию для того, чтобысудитьо многихпроцессах,протекающих наповерхности образца.Во многихслучаях высокая чувствительность иширокие возможности метода ВИМС компенсируют недостаточную количественнуюточность, позволяяизвлекатькачественные илиполуколичественные сведения (особенно в плане качественногоконтроля приприготовлении иобработке поверхности ), которые невозможно получить другими методами.
Глубинные профили концентрации
ВИМС - одиниз самых эффективных методовдиагностики поверхности среди применяемых для измеренияраспределения концентрацииэлементовпо глубинеобразца. Предел разрешенияпоглубине притакомметоде не превышает50 А,а порог чувствительностименьше 1017 атом/см2.
В настоящее время для изменения свойств приповерхностного слоя твердого тела широко пользуются методам ионного внедрения (имплантации). Распределение внедренных частиц по глубине определяют разными методами (радиоактивные изотопы, измерение электропроводимости, рентгеновские лучи, возникающие при бомбардировке тяжелыми ионами). Но применение подобных методов сопряжено с большими трудностями и возможно далеко не при всех сочетаниях легирующий ион - матрица. Метод ВИМС же свободен от таких ограничений и потому наиболее удобен при определении профилей концентрации внедренных частиц.
Распределение частиц по поверхности, микроанализ и объемный анализ
Рентгеновский микроанализ открылпуть длядиагностики твердыхтел идосегодняшнего дняостается важнейшимметодом такогоанализа. Создание приборов ВИМС типамасс-спектральнагомикроскопа ирастровогомикрозонда расширило возможности микроанализатвердоготела, позволивдостичь большейчувствительности,проводить изотопическийиповерхностный анализиобнаруживать присутствиеэлементов с малыми Z.
Масс-спектральныемикроскопы даюткачественную,а принекоторых условиях и количественную информацию о распределении элементов по поверхности образца. Они применяются при изучении выделений на границах зерен, различных эффектов и поли- и моно-кристаллах, диффузии(двумерного распределенияв плоскостипоперечныхшлифов), фазового состава минералови распределения поверхностных загрязнений.
Методом ВИМС проводится анализ двоякого рода: определение общего состава в объеме твердого тела и определение состава в отдельных его точках (т. е микрообластях диаметром менее 25 мкм). Микроанализ методом ВИМС проводился для определения следов различных элементов, содержащихся в тех или иных зернах минералов, изотопического анализа РЬ in situ в ореоле радиоактивных включений (диаметром 1 - 2 мкм), элементного анализа взвесии определения возраста некоторых фаз в минералах по отношению 207Pb/206Pbи рубидиево-стронциевым методом. Анализ активных газов (таких, как Н2, N2, О2) в металлах этим методом сопряжен с известными трудностями.
Заключение
Пока что нет такого метода, который полностью удовлетворял бы всем запросам всех исследователей, имеющих дело с поверхностью. Метод ВИМС не является исключением в этом отношении, но он занимает особое положение в области анализа состава объема и поверхности твердого тела, т. к. в ряде других отношений с ним не могут сравниться никакие другие методы. Высокочувствительность к большинству элементов, возможность регистрации атомов с малыми Z и изотопического анализа, высокое разрешение по глубине при измерении профилей концентрации и возможность изучения распределения элементов по поверхности делают ВИМС методом трехмерного анализа изотопного и следового состава твердого тела (фиг. 14).
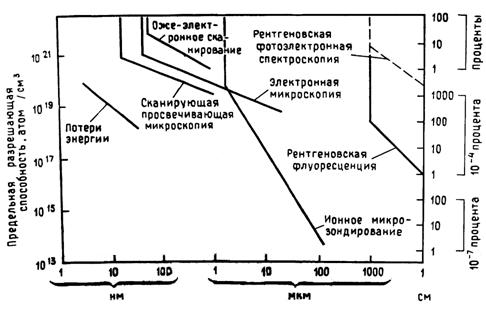
Фиг.14. Влияние анализируемой площади на предельную разрешающую способность[2].
Многие задачи физики поверхности могут быть решены качественными или полуколичественными методами, поэтому, не очень высокая точность количественных оценок, обеспечиваемая методом ВИМС, с лихвой компенсируется той ценной качественной информацией, которую он дает. ВИМС уже оказал большое влияние на микроанализ твердых тел в направлениях, имеющих как фундаментальное, так и прикладное значение. Дальнейшее развитие метода ВИМС должно быть направлено, главным образом, на решение проблемы количественного анализа и отыскания путей повышения его точности.
Список литературы
1. Мак-Хью И.А. Вторично-ионная масс-спектрометрия: В кн. Методы анализа поверхности./Пер с англ. - М.: Мир, 1979. - с. 276-342.
2. Броудай И., Мерей Дж. Физические основы микротехнологии: Пер. с англ. - М.: Мир, 1985. - 496 с.
3. Технология СБИС: В 2-х кн. Пер. с англ./Под ред. С. Зи. - М.: Мир, 1986. - 453 с.
4. Черепин В.Т., Васильев М.А. Методы и приборы для анализа поверхности материалов: Справочник. - Киев: Наукова Думка, 1982. - 400 с.
5. Фелдман Л., Майер Д. Основы анализа поверхности и тонких пленок./Пер. с англ. - М.: Мир, 1989. - 342 с.
6. Добрецов Л.Н., Гомоюнова М.В. Эмиссионная электроника. - М.: Наука, 1966. - 564 с.
7. Векслер В.И. Вторичная ионная эмиссия металлов. - М.: Наука, 1978. - 240 с.